bahan nano








Array yang dipesan secara berkala dari kawat nano Si (Si NWs) yang disejajarkan secara vertikal berhasil dibuat oleh litografi nanosfer yang dikombinasikan dengan etsa kimia berbantuan logam. Dengan menyesuaikan waktu etsa, diameter dan panjang kawat nano dapat dikontrol dengan baik. Sifat konduktif dari Si NWs tersebut dan khususnya ketergantungan ukurannya diselidiki oleh mikroskop gaya atom konduktif (CAFM) pada kawat nano individu. Hasilnya menunjukkan bahwa konduktansi Si NWs sangat relevan dengan diameter dan panjangnya. Si NWs dengan diameter yang lebih kecil dan panjang yang lebih pendek menunjukkan sifat konduktif yang lebih baik. Bersama dengan karakterisasi kurva IV, mekanisme yang mungkin diduga dengan sudut pandang ketinggian penghalang Schottky yang bergantung pada ukuran, yang selanjutnya diverifikasi oleh pengukuran mikroskop gaya elektrostatik (EFM). Studi ini juga menunjukkan bahwa CAFM dapat bertindak sebagai cara yang efektif untuk mengeksplorasi ukuran (atau parameter lain) ketergantungan sifat konduktif pada struktur nano individu, yang seharusnya penting untuk optimasi fabrikasi dan aplikasi potensial dari struktur nano.
Kawat nano silikon (Si NWs) telah mendapatkan aplikasi yang menjanjikan dalam bidang elektronik, fotonik, optoelektronik dan banyak bidang lainnya karena rasio aspek yang tinggi dan sifat listrik, termoelektrik dan fotolistrik yang unik, serta kompatibilitas dengan teknologi silikon tradisional [1,2,3 ,4,5]. Dalam beberapa dekade terakhir, penelitian Si NWs terutama berfokus pada peningkatan pertumbuhan dan pengukuran properti. Banyak metode telah dikembangkan untuk mempersiapkan Si NWs, termasuk metode bottom-up seperti metode uap-cair-padat, deposisi uap kimia, dan epitaksi berkas molekul [6,7,8,9,10] dan pendekatan top-down menggunakan elektron -beam litografi, etsa ion reaktif atau etsa kimia berbantuan logam [11,12,13,14,15,16]. Di antara metode-metode ini, litografi nanosfer (NSL) yang dikombinasikan dengan etsa kimia berbantuan logam (MACE) telah diadopsi secara intensif untuk membuat susunan terurut area besar dari Si NWs yang selaras secara vertikal karena kesederhanaannya, biaya rendah, dan keserbagunaannya [15,16,17] ,18,19,20,21,22,23]. Si NWs yang dicapai oleh MACE biasanya memiliki permukaan yang sangat kasar dan bahkan berpori [18,19,20,21], yang hanya membuat mereka memiliki luas permukaan spesifik yang besar dan sifat yang sangat baik, yang mengarah ke potensi aplikasi yang besar dalam biosensor, perangkat termoelektrik, lithium baterai -ion, sel surya, dll. [22,23,24]. Untuk mewujudkan aplikasi tersebut, penting untuk mendapatkan pemahaman yang baik tentang sifat listriknya. Saat ini dua jenis metode telah sering diterapkan untuk menyelidiki sifat listrik kawat nano. Salah satunya dilakukan dengan metode makroskopik biasa, yang relatif mudah dilakukan tetapi hanya dapat memberikan hasil rata-rata pada perakitan besar kawat nano [24, 25]. Yang lainnya dilakukan pada kawat nano individu dengan perangkat kawat nano tunggal fabrikasi khusus [21, 26,27,28], yang dapat mengecualikan pengaruh ketidakhomogenan ukuran tetapi tidak mudah untuk dicapai, terutama ketika mengukur ketergantungan properti. Oleh karena itu, metode yang lebih nyaman untuk mempelajari sifat listrik pada NW individu tanpa fabrikasi nano yang kompleks sangat diperlukan.
Dalam beberapa dekade terakhir, pengukuran listrik berbasis scanning probe microscopy (SPM) mengungkapkan diri mereka sebagai teknik yang kuat untuk karakterisasi listrik pada skala nano [29, 30]. Di antara teknik SPM ini, mikroskop gaya atom konduktif (CAFM) telah berhasil diterapkan untuk mempelajari sifat konduktif pada struktur nano tunggal atau individu [30,31,32]. Penyelidikan CAFM pada berbagai kawat nano, seperti ZnO, InAs, CdS, CdSe, GaAs, InAsSb, dan Si NWs, telah dilaporkan [33,34,35,36,37,38]. Sementara sebagian besar penelitian berfokus pada sifat konduktif kawat nano dengan parameter tetap, beberapa penyelidikan dilakukan untuk mengeksplorasi ketergantungan doping dari sifat konduktif [37,38,39]. Ketergantungan ukuran dari sifat konduktif kawat nano telah jauh lebih sedikit diselidiki. Hanya beberapa penelitian yang telah dilaporkan tentang sifat konduktif tergantung diameter kawat nano, bahkan tidak terbatas pada CAFM, dan sebagian besar dari mereka berurusan dengan ketergantungan diameter resistivitas kawat nano [25, 40,41,42]. Misalnya, beberapa penelitian tentang kawat nano GaN menemukan bahwa resistivitas tinggi pada diameter kritis (20 ~ 80 nm, tergantung pada metode fabrikasi) dan tetap tidak berubah di luar itu [41, 43], sedangkan penelitian lain pada kawat nano Si melaporkan bahwa resistivitas kawat nano menurun dengan meningkatnya diameter dalam kisaran puluhan hingga ratusan nanometer [40, 44]. Untuk kawat nano semikonduktor dengan kontak logam, penghalang Schottky mungkin memainkan peran penting dalam sifat konduktifnya. Oleh karena itu, kecuali untuk resistivitas, penghalang Schottky harus dipertimbangkan dengan adanya kawat nano semikonduktor. Beberapa makalah telah berfokus pada ketergantungan diameter tinggi penghalang Schottky (SBH), tetapi hasilnya tidak konsisten. Misalnya, Calahorra et al. menghitung SBH dengan memecahkan persamaan Poisson di kawat nano, dan menemukan tren yang jelas dari peningkatan tinggi penghalang dengan pengurangan ukuran [45]. Ketergantungan diameter serupa dilaporkan secara eksperimental oleh Soudi et al. ketika menyelidiki tegangan foto permukaan yang bergantung pada diameter dan kerapatan keadaan permukaan pada perangkat kawat nano tunggal ZnO. Mereka menemukan bahwa ketinggian penghalang permukaan meningkat dengan penurunan diameter (20-60 nm), yang ditafsirkan oleh kepadatan keadaan permukaan yang disimulasikan menggunakan persamaan Poisson [46]. Sebaliknya, pemindaian pengukuran mikroskop arus foto pada transistor efek medan nanowire Si tunggal oleh Yoon et al. mengungkapkan ketergantungan yang berlawanan, yaitu, ketinggian penghalang menurun dengan diameter yang menurun karena kontribusi status antarmuka [47]. Karya eksperimental lain oleh Mao et al. pada dioda Schottky nanoneedle Pt/ZnO tunggal juga melaporkan ketinggian penghalang menurun dengan diameter menurun, yang dijelaskan oleh efek pemanasan joule dan/atau ketidakhomogenan elektronik antarmuka [48]. Oleh karena itu hingga saat ini, ketergantungan diameter dari sifat konduktif kawat nano belum mencapai konsensus dan masih jauh dari pemahaman yang menyeluruh. Khususnya, sifat konduktif yang bergantung pada ukuran serta studi SBH yang bergantung pada ukuran belum dilaporkan pada masing-masing Si NW yang dibuat dengan metode MACE, yang memiliki permukaan yang cukup kasar untuk aplikasi yang menjanjikan.
Dalam makalah ini, susunan periodik Si NWs yang disejajarkan secara vertikal dengan diameter dan panjang yang berbeda disiapkan dengan metode NSL yang dikombinasikan dengan MACE. Baik diameter dan panjang SiNWs dapat dikontrol dengan baik dengan menyesuaikan waktu etsa. Sifat konduktif dari Si NWs individu di dalam array diselidiki oleh CAFM tanpa nanofabrication lebih lanjut, yang dapat mempelajari sifat konduktif yang bergantung pada ukuran pada Si NWs individu dengan mudah hanya dengan mengganti sampel. Hasilnya menunjukkan bahwa arus yang diukur pada masing-masing Si NW sangat bergantung pada diameter dan panjang NW. Si NWs dengan diameter yang lebih kecil dan panjang yang lebih pendek menunjukkan sifat konduktif yang lebih baik. Dari pemasangan kurva I–V, ketinggian penghalang Schottky yang bergantung pada ukuran dapat diperoleh, yang ditemukan bertindak sebagai faktor kunci untuk menentukan sifat konduktif yang bergantung pada ukuran dari kawat nano. Lebih lanjut, SBH yang bergantung pada ukuran serupa diperoleh dengan pengukuran mikroskop gaya elektrostatik (EFM). Oleh karena itu, penelitian kami tidak hanya mengungkapkan sifat tergantung ukuran Si NWs tetapi juga menunjukkan bahwa CAFM dapat bertindak sebagai cara yang efektif untuk mengeksplorasi ukuran (atau parameter lain) ketergantungan sifat konduktif pada struktur nano individu.
Wafer Si dibeli dari MTI (China). Suspensi (2,5 wt% dalam air) bola polistiren (PS, diameter 490 nm) dibeli dari Duke Scientific (AS). Aseton, metanol, asam sulfat, hidrogen peroksida, dan asam fluorida untuk fabrikasi Si NWs dibeli dari Sinopharm Chemical Reagent (Cina). Air deionisasi (DI, 18,2 MΩ·cm) diperoleh dari sistem ultrafiltrasi (Milli-Q, Millipore, Marlborough, MA).
Susunan kawat nano silikon yang dipesan secara vertikal dibuat oleh NSL yang dikombinasikan dengan MACE, yang telah dijelaskan secara rinci dalam literatur sebelumnya [49, 50]. Proses fabrikasi utama dijadwalkan pada Gambar 1a. Pertama, lapisan tunggal bola polistiren (PS) dengan diameter 490 nm dirakit sendiri ke wafer Si planar yang dibersihkan secara kimia (tipe-n, 0,01 Ω cm) untuk membentuk lapisan tunggal heksagonal yang rapat. Selanjutnya, sampel tertutup PS digores dengan etsa ion reaktif (RIE, Teknologi Trion) (50 W, 70 mTorr) dengan O2 gas (20 sccm) untuk mengurangi diameter PS, yang bertindak sebagai lapisan topeng dalam prosedur berikut. Setelah itu, film Au 20 nm diendapkan dengan sputtering ion ke sampel yang ditutupi oleh lapisan PS yang bertindak sebagai katalis untuk perawatan MACE berikut. Sampel diperlakukan dengan MACE di HF (40%) dan H2 O2 (30%) larutan campuran (perbandingan volume 4:1) pada suhu kamar. Dalam proses MACE, permukaan Si yang dilapisi Au tergores secara efektif sedangkan yang ditutupi oleh PS (tanpa Au) dilindungi, menghasilkan pembentukan Si NWs. Terakhir, lapisan Au yang tersisa dan bola PS dihilangkan dengan merendam sampel dalam KI/I2 dan larutan tetrahidrofuran. Dengan metode fabrikasi ini, array periodik area besar dari array Si NW yang sejajar secara vertikal dapat diperoleh.

a Ilustrasi skema dari prosedur untuk membuat susunan kawat nano Si yang disejajarkan secara vertikal. b Diagram skema pengaturan eksperimental untuk pengukuran CAFM dan EFM pada kawat nano Si individu
Morfologi Si NWs yang dibuat diperiksa dengan memindai mikroskop elektron (SEM, SIGMA300) sementara sifat strukturalnya diselidiki dengan spektroskopi Raman (sistem Jobin Yvon HR-Evolution 2) dengan panjang gelombang eksitasi 532 nm dan daya rendah sekitar 1 mW .
Sifat listrik Si NWs diselidiki oleh CAFM dan EFM dengan peralatan SPM komersial (Multimode V, Bruker Nano Surfaces), seperti yang digambarkan pada Gambar. 1b. Ujung berlapis Cr/Pt (Multi75E-G, Sensor Anggaran, radius sekitar 25 nm) digunakan untuk pengukuran CAFM dan EFM. Dalam CAFM, ujung konduktif dipindai di atas permukaan sampel dalam mode kontak dengan tegangan bias DC yang diterapkan ke substrat sementara ujungnya diarde, dan arus antara ujung dan sampel diukur. Karena oksidasi anodik permukaan serius di bawah bias sampel positif, semua gambar saat ini diukur pada bias sampel negatif. Berbagai tegangan negatif berkisar dari 0,5 hingga 3,0 V diuji dalam eksperimen CAFM. Ditemukan, ketika tegangan bias diatur di bawah 1,5 V, arusnya terlalu kecil untuk dideteksi untuk sampel dengan konduktansi yang buruk. Sementara tegangan bias ditetapkan sebagai 2.0 V atau lebih besar, pengukurannya tidak stabil, mungkin karena kerusakan ujung dan/atau sampel di bawah medan elektrostatik yang besar. Oleh karena itu, tegangan bias 1,5 V dipilih untuk pengukuran gambar saat ini. Pengukuran EFM dilakukan pada Si NWs dalam mode dua lintasan. Pada lintasan pertama, ia bekerja dalam mode sadap untuk mendapatkan gambar topografi, sedangkan pada lintasan kedua ujungnya diangkat cukup tinggi untuk mengabaikan gaya Van der Waals. Pada lintasan yang diangkat, tegangan DC ditambahkan antara sampel dan ujung yang diarde, dan sinyal pergeseran fasa yang diinduksi oleh gaya elektrostatik terdeteksi. Semua eksperimen dioperasikan dalam aliran N2 ambient untuk pengukuran listrik yang stabil dan sampel dicelupkan sebelumnya ke dalam larutan HF (5%) selama 30 detik untuk secara efektif mengurangi pengaruh lapisan oksida pada karakterisasi konduktif. Karena pengukuran dilakukan segera setelah pencelupan HF, lapisan oksigen yang direformasi harus cukup tipis untuk ditembus oleh ujung konduktif dan efeknya pada konduktansi minimal.
Pembuatan susunan kawat nano Si terurut vertikal dengan area luas diilustrasikan pada Gambar. 1a. Dengan mengubah waktu RIE, diameter bola PS dapat dikurangi ke nilai yang diinginkan, dan karenanya Si NWs dengan diameter yang dapat dikontrol dapat dicapai. Gambar SEM dari Si NW yang diperoleh setelah etsa RIE 90, 120, dan 150 disajikan masing-masing pada Gambar 2 a, b, dan c. Dapat diamati bahwa Si NWs disejajarkan secara vertikal dalam pengaturan heksagonal berkala di area yang luas. Si NW yang disejajarkan secara vertikal ini memiliki periode yang sama yaitu 490 nm dan panjang yang sama sekitar 350 nm (waktu MACE yang sama yaitu 40 s). Diameter Si NWs di (a), (b), dan (c) masing-masing sekitar 350, 260 dan 190 nm. Ketergantungan diameter NWs pada waktu etsa RIE diplot pada Gambar. 2d, menunjukkan korelasi linier yang baik. Di sisi lain, panjang kawat nano dapat disesuaikan dengan memvariasikan waktu MACE dalam HF dan H2 O2 larutan campuran. Gambar SEM cross-sectional Si NWs setelah 40, 60, 80, dan 100 s MACE ditunjukkan pada Gambar. 2e. Dapat dilihat bahwa panjang NWs meningkat dari 350 menjadi 960 nm dengan meningkatkan waktu MACE. Demikian pula, panjang Si NWs menunjukkan ketergantungan linier yang baik pada waktu MACE, seperti yang ditunjukkan pada Gambar. 2f. Hasil ini menunjukkan bahwa Si NW yang dipesan dengan diameter dan panjang yang dapat dikontrol berhasil dibuat dengan metode NSL yang dikombinasikan dengan MACE.
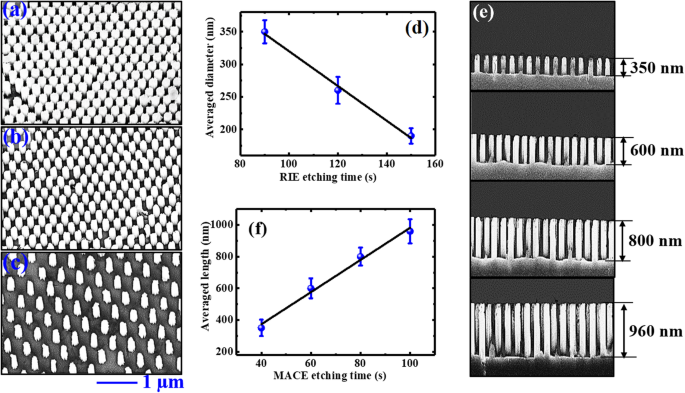
Gambar SEM tampak atas dari Si NWs dengan panjang yang sama 350 nm, tetapi diameter a yang berbeda 350 nm; b 260 nm; dan c 190 nm. Ketergantungan diameter NWs pada waktu etsa RIE diplot dalam d . e Gambar SEM penampang Si NWs dengan diameter yang sama 260 nm, tetapi panjangnya berbeda 350, 600, 800, dan 960 nm. f Menampilkan ketergantungan panjang NW pada waktu MACE
Dari gambar SEM, dapat juga ditemukan bahwa Si NWs memiliki permukaan yang sangat kasar setelah etsa kimia, dan permukaan dinding sampingnya sangat kasar. Untuk memeriksa struktur mikro lapisan permukaan sebagai fungsi diameter dan panjang, spektrum Raman diukur pada kedua massa Si dan Si NWs dengan diameter yang berbeda dan panjang yang berbeda. Setiap spektrum dinormalisasi dengan menggunakan intensitas puncak maksimum pada 520 cm − 1 , dan hasil untuk diameter yang berbeda dan panjang yang berbeda masing-masing ditunjukkan pada Gambar 3 a dan b. Spektrum silikon curah menunjukkan puncak tajam yang terletak di ~ 520.1 cm − 1 . Pergeseran merah posisi puncak dan pelebaran lebar puncak (disebut dengan lebar penuh pada setengah maksimum, FWHM) dapat diamati pada Si NWs, seperti yang diplot pada Gambar 3 c dan d. Pergeseran merah puncak dan pelebaran agak kecil untuk kawat nano dengan panjang pendek 350 dan 600 nm dan menjadi relatif jelas ketika panjang kawat nano meningkat menjadi 800 nm ke atas. Pergeseran merah dan pelebaran puncak Raman terkadang dikaitkan dengan perubahan tingkat dopan atau kandungan kristal. Menurut literatur sebelumnya [5, 51], untuk Si NWs yang dibuat dengan metode MACE yang sama, konsentrasi doping dapat memiliki tingkat doping yang sama dengan wafer awal. Karena keterbatasan peralatan, kami tidak dapat mengkonfirmasi hasil ini. Di sisi lain, meskipun Si NWs ini memiliki permukaan yang kasar, literatur sebelumnya menemukan bahwa Si NWs yang dibuat dengan metode MACE terutama dapat mempertahankan struktur kristalnya untuk doping n dan p serta doping ringan dan berat [5, 51 , 52]. Hanya lapisan amorf tipis yang diamati pada permukaan dinding NWs. Hasil serupa diperoleh pada Si NWs dengan diameter dan panjang yang berbeda oleh kelompok yang berbeda. Dengan demikian, dapat diasumsikan bahwa Si NW yang dibuat dengan metode MACE dapat menjaga tingkat dopan dan kandungan kristalnya hampir tidak berubah sebagai rekan curahnya, kecuali lapisan permukaan yang tipis.

Spektrum Raman khas dari kawat nano Si dan Si massal dengan a panjang yang sama 350 nm tetapi diameter dan b . yang berbeda diameter yang sama 190 nm tetapi panjangnya berbeda. c dan d mewakili pergeseran merah posisi puncak dan pelebaran FWHM sebagai fungsi dari panjang kawat nano
Oleh karena itu, pergeseran dan pelebaran puncak Raman kemungkinan besar disebabkan oleh permukaan kasar kawat nano yang rusak [53]. Ada beberapa makalah yang melaporkan hasil Raman dari Si NWs yang dibuat dengan metode MACE yang sama. Misalnya, Feser et al. menemukan bahwa pelebaran puncak yang signifikan pada 520 cm − 1 meningkat dengan waktu MACE dan menghubungkan pelebaran puncak ini dengan gangguan kristal (misalnya, kelompok cacat titik) yang disebabkan oleh proses etsa [23]. Lajvardi dkk. menemukan bahwa pergeseran merah Raman meningkat dengan waktu MACE, i. e. puncak TO Raman terletak di 521.1 cm − 1 untuk Si massal dan digeser ke 518,7 cm − 1 untuk sampel tergores 80 menit, masing-masing [54]. Mereka menyatakan bahwa asal usul pergeseran Raman mungkin karena pembentukan kristal nano Si di dinding kawat nano. Lin dkk. mengamati bahwa puncak TO Raman bergeser dari 520 ke 516 cm − 1 ketika panjang NWs bertambah dari 0 (bulk Si) menjadi 2,73 μm, sedangkan lebar puncak diperluas dari 3 menjadi 9 cm − 1 dengan meningkatnya panjang NW dari 0,19 menjadi 2,73 μm [55]. Mereka berpikir bahwa pelebaran puncak Raman didominasi oleh interaksi regangan fonon dan pergeseran puncak Raman terbukti sebanding dengan distorsi kisi permukaan yang diinduksi regangan. Karena regangan yang disebabkan oleh etsa HF meningkat dengan panjang NW (lebih banyak waktu etsa), pergeseran merah puncak Raman dan pelebaran meningkat dengan meningkatnya panjang NW. Dalam kasus kami, dari spektrum Raman seperti yang ditunjukkan pada Gambar. 3 a dan b, kami dapat menemukan bahwa puncak TO Raman bergeser dari 520 ke 519,4 cm − 1 ketika panjang NWs meningkat dari 0 (bulk Si) menjadi 960 nm, sedangkan FWHM diperluas dari 4,41 menjadi 4,47 cm − 1 seiring bertambahnya panjang NW dari 350 menjadi 960 nm. Kami lebih suka pergeseran dan pelebaran puncak Raman yang bergantung pada panjang ini berasal dari permukaan yang rusak (regangan atau gangguan). Namun, karena variasi yang sangat kecil dalam pergeseran merah dan pelebaran puncak untuk kawat nano dengan diameter dan panjang berbeda (< 1.0 cm − 1 ), perubahan regangan/gangguan dengan ukuran dapat dianggap minimal. Jadi regangan/gangguan dapat mengubah konduktansi NW, tetapi pengaruhnya pada ketergantungan ukuran konduktansi tidak dibahas di bagian selanjutnya.
Sifat konduktif Si NW diukur dengan CAFM pada masing-masing NW dengan diameter dan panjang yang berbeda. Gambar topografi tipikal dari Si NWs yang disejajarkan secara vertikal dengan panjang yang sama 350 nm tetapi diameter berbeda 350, 260, dan 190 nm masing-masing ditunjukkan pada Gambar. 4 a, b dan c, sedangkan gambar yang sesuai saat ini diperoleh pada sampel bias 1.5 V disajikan pada (d), (e), dan (f). Perlu dicatat, karena ujung AFM berlapis Cr/Pt adalah irisan dengan sudut besar, Si NWs menunjukkan diameter yang lebih besar daripada yang sebenarnya. Selain itu, arus keluar dari kawat nano tidak dapat dideteksi dengan baik karena ujungnya mungkin tidak dapat bersentuhan dengan substrat, jadi hanya arus yang diukur pada kawat nano yang diperhitungkan. Dari gambar saat ini, dapat diamati bahwa sebagian besar tepi kawat nano Si menunjukkan konduktansi yang sedikit lebih baik daripada pusatnya. Ini mungkin diakibatkan oleh kontak samping antara ujung AFM dan Si NW dengan area kontak yang lebih besar. Selain itu, karena kekasaran yang jelas pada permukaan atas, beberapa daerah di area tengah juga dapat menunjukkan arus besar yang mirip dengan tepi, sehingga tidak ada distribusi arus seperti cincin yang berbeda. Di sisi lain, konduktansi Si NWs jelas terkait dengan diameter kawat nano. Dapat dilihat bahwa rasio area konduktif kawat nano dan nilai arus absolut meningkat secara signifikan seiring dengan penurunan diameter dari 350 menjadi 190 nm. Hasilnya menunjukkan bahwa Si NWs dengan diameter lebih kecil lebih konduktif dibandingkan dengan yang lebih besar. Untuk mendapatkan ketergantungan diameter lebih intuitif, profil saat ini sepanjang garis ditandai pada Gambar. 4 d ke f ditampilkan pada Gambar. 4g. Ini jelas menunjukkan bahwa Si NWs dengan diameter 190 nm jauh lebih konduktif dibandingkan dengan diameter 260 nm dan 350 nm. Ketergantungan diameter tersebut juga dapat diperoleh dari histogram statistik dari distribusi arus pada Si NWs dengan diameter yang berbeda, seperti yang ditunjukkan pada File tambahan 1:Gambar S1(a), yang menunjukkan distribusi arus bergeser ke nilai tinggi saat diameter berkurang. Arus rata-rata (I av ) dari Si NW dihitung dengan rata-rata arus pada semua kawat nano dalam gambar saat ini, yang diplot pada Gambar 4h sebagai fungsi diameter NW. Arus rata-rata Si NWs menunjukkan peningkatan dramatis sembilan kali lipat ketika diameter NWs menurun dari 350 menjadi 190 nm. Ketergantungan arus serupa pada diameter telah dicapai pada kawat nano InAs tunggal serta pada perangkat kawat nano Si tunggal [35, 47].

Gambar topografi Si NWs dengan panjang yang sama 350 nm tetapi diameter a yang berbeda 350 nm, b 260 nm, c 190 nm. Gambar saat ini yang sesuai yang diperoleh di bawah bias sampel 1,5 V diberikan dalam d , e dan f , masing-masing. Profil saat ini di sepanjang garis yang ditandai di d –f diplot dalam g , dan h menyajikan arus rata-rata (I av ) di atas kawat nano sebagai fungsi dari diameter NWs. Garis yang sesuai ditambahkan dalam gambar topografi a –c dan kurva profil di g digeser secara vertikal untuk panduan
Gambar arus khas Si NW dengan panjang berbeda dan diameter 190 nm yang sama diukur pada bias sampel 1,5 V disajikan pada Gambar. 5. Gambar 5 a hingga d menunjukkan gambar Si NW saat ini dengan panjang 350, 600, 800, dan 960 nm, masing-masing. Dapat dilihat bahwa pada gambar arus ini, daerah konduktif menurun dengan jelas dengan bertambahnya panjang, sedangkan penurunan arus absolut tidak begitu jelas, terutama untuk NW dengan panjang 350 nm dan 600 nm. Mungkin karena adanya kekasaran permukaan tidak beraturan lokal, arus yang lebih besar diamati di beberapa titik pada Gambar 5b. Namun demikian, arus rata-rata dari Gambar 5b jauh lebih kecil dari pada Gambar 5a. Menggunakan analisis yang sama seperti di atas, profil saat ini di sepanjang garis yang ditandai disajikan pada Gambar. 5e, dan histogram statistik ditunjukkan pada File tambahan 1:Gambar S1(b). Keduanya jelas menunjukkan penurunan arus yang signifikan dengan peningkatan panjang NW. Arus rata-rata kawat nano sebagai fungsi dari panjang NW diplot pada Gambar 5f, dan arus tersebut berada pada orde puluhan hingga ratusan pA yang jauh lebih kecil daripada yang ditunjukkan pada Gambar 5 a hingga e pada orde nA . Itu karena kawat nano menunjukkan arus yang relatif besar hanya di beberapa titik konduktif ketika sebagian besar wilayah nonkonduktif. Dari Gambar. 5f, arus rata-rata menunjukkan penurunan lebih dari tiga kali lipat ketika panjang bertambah dari 300 menjadi 960 nm, menunjukkan konduktansi kawat nano menurun dengan bertambahnya panjang. Ketergantungan resistansi kawat nano pada panjang sebelumnya telah diselidiki oleh pengukuran resistansi empat titik pada kawat nano semikonduktor, yang menunjukkan bahwa di bawah kontak Ohmic resistansi kawat nano meningkat dengan panjangnya secara linier dengan kemiringan resistivitas [56, 57]. Dalam kasus kami, dari plot I ~ 1/L seperti yang diberikan dalam file tambahan 1:Gambar S2, ketergantungannya sangat nonlinier; karenanya, resistivitas tidak dapat diperoleh dengan benar dari kemiringan kurva. Perlu dicatat dalam pengukuran CAFM, resistansi terukur total mencakup resistansi kontak antara ujung berlapis Cr/Pt dan Si NW (R tip/NW ), hambatan Si NW (R NW ) dan ketahanan wafer Si (R massal ). Karena resistansi yang diukur oleh CAFM terutama berasal dari area permukaan lokal di bawah ujung dan menurun dengan cepat dengan meningkatnya area di sepanjang jalur saat ini, R massal jauh lebih kecil dibandingkan dengan R NW dan R tip/NW . Di sisi lain, karena area kontak semikonduktor logam yang sangat kecil antara ujung dan kawat nano, resistansi kontak R tip/NW jauh lebih besar daripada resistansi kawat nano R NW . Ketidaklinieran ketergantungan arus pada 1/L hanya menunjukkan adanya hambatan kontak yang besar. Oleh karena itu, dalam pengukuran yang dilakukan oleh CAFM, resistansi kontak logam-semikonduktor harus dipertimbangkan secara tegas, di mana penghalang Schottky memainkan peran penting.

Gambar Si NWs saat ini di bawah bias sampel 1,5 V dengan diameter yang sama 190 nm tetapi panjang a yang berbeda 350 nm, b 600 nm, c 800 nm, dan d 960 nm, masing-masing. Profil saat ini di sepanjang garis yang ditandai di a –d diplot dalam e , dan f menyajikan arus rata-rata dari kawat nano (I av ) sebagai fungsi dari panjang NWs. Kurva profil di e digeser secara vertikal untuk panduan
Untuk memverifikasi kesimpulan di atas, kurva arus-tegangan (I–V) direkam pada Si NWs individu untuk menyelidiki penghalang Schottky di ujung logam / kontak nanowire Si. Kurva IV khas pada Si NWs dengan panjang yang sama 350 nm tetapi diameter yang berbeda disajikan pada Gambar. 6a dan pada Si NWs dengan diameter yang sama 190 nm tetapi panjang yang berbeda ditampilkan pada Gambar. 6b, masing-masing. Semua kurva I-V menunjukkan arus yang lebih besar pada daerah tegangan sampel negatif, sesuai dengan kurva IV khas dengan kontak Schottky antara ujung logam dan semikonduktor tipe-n. Karena kurva I–V menunjukkan karakteristik semikonduktor logam yang baik, ini menunjukkan bahwa efek lapisan oksigen pada konduktansi tidak serius dan dengan demikian diasumsikan minimal dalam diskusi berikut. Sementara itu, hasil menunjukkan bahwa kawat nano yang lebih kecil dan lebih pendek menunjukkan konduktansi yang lebih besar daripada yang lebih besar dan lebih panjang, konsisten dengan hasil yang diperoleh dari gambar saat ini. Untuk analisis kuantitatif, model emisi termionik terkenal untuk kontak logam-semikonduktor diadopsi [58, 59]. Dalam model ini, karakteristik I–V dari kontak Schottky ke semikonduktor tipe-n dengan adanya resistansi seri dapat didekati sebagai [59]:
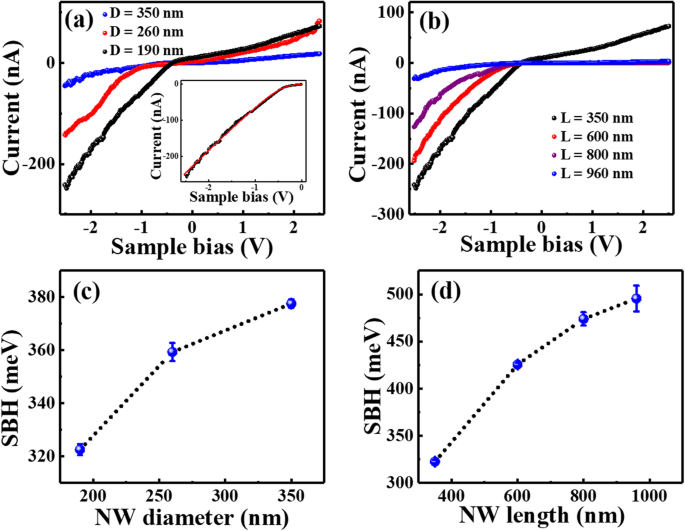
Kurva IV khas pada Si NWs dengan panjang yang sama 350 nm tetapi diameter yang berbeda (a ) dan diameter yang sama 190 nm tetapi panjangnya berbeda (b ). Sisipan dalam a menunjukkan hasil pemasangan khas Si NWs dengan diameter 190 nm dan panjang 350 nm. c dan d mewakili ketinggian penghalang Schottky yang diperoleh dari hasil pemasangan sebagai fungsi diameter dan panjang NW, masing-masing
$$ I={I}_S\left[\exp \left(\frac{q\left(VI{R}_S\right)}{\mathrm{n} kT}\right)-1\right], $ $ (1)dimana n adalah faktor ideal dan R S adalah hambatan seri. Aku S adalah arus saturasi, yang dapat dinyatakan dengan:
$$ {I}_S=\mathrm{AA}\ast {T}^2\exp \left(-\frac{\varphi_B}{kT}\right), $$ (2)di mana A adalah bidang kontak, A* adalah konstanta Richardson, dan φ B adalah ketinggian penghalang Schottky (SBH) antara ujung logam dan kawat nano Si. Dengan demikian, SBH dapat diperoleh dengan rumus:
$$ {\varphi}_B=kT\ln \left(\frac{\mathrm{AA}\ast {T}^2}{I_{\mathrm{S}}}\right), $$ (3)Kurva I-V pada Gambar. 6 a dan b dapat dipasang dengan baik oleh Persamaan. (1), dan garis pas tipikal di daerah depan ditunjukkan pada sisipan Gambar 6a. Untuk mendapatkan nilai SBH dari arus saturasi, konstanta Richardson efektif A* diasumsikan kira-kira sama dengan silikon curah, yaitu 112 A cm − 2 K − 2 untuk silikon tipe-n [59]. Area kontak diasumsikan 2 × 10 − 11 cm 2 dengan mengambil jari-jari ujung berlapis Cr/Pt sebagai 25 nm. Nilai SBH diperoleh sekitar 322, 359 dan 377 meV untuk Si NWs dengan panjang yang sama 350 nm dan diameter yang berbeda masing-masing 190, 260 dan 350 nm. Untuk Si NW dengan diameter 190 nm yang sama dan panjang berbeda 350, 600, 800 dan 960 nm, nilai SBH adalah 322, 425, 473 dan 495 meV, secara berurutan. Sebagai perbandingan, kurva I–V tipikal diukur pada jenis wafer Si yang sama, seperti yang ditunjukkan pada File tambahan 1:Gambar S3(a). Ini jelas menunjukkan bahwa konduktansi wafer Si jauh lebih kecil daripada NWs yang dihasilkan. Arus yang dapat dideteksi hanya dapat diukur pada tegangan bias tinggi (− 4 ~ 10 V). Setelah memasang kurva I–V dengan model emisi termionik di atas (File tambahan 1:Gambar S3(b)), nilai SBH 0,60 eV diperoleh untuk Si massal. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Mao dkk. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)dimana C , V EFM , dan V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ contoh − φ kiat )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)dimana Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
Dari Persamaan. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E B ). Sebagai E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c dan d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a dan b are vertically shifted for guidance
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
The datasets used for supporting the conclusion are included in the article and the supporting file.
Conductive atomic force microscopy
Contact potential difference
Electrostatic force microscopy
Etsa kimia dengan bantuan logam
Nanosphere lithography
Polystyrene spheres
Etsa ion reaktif
Tinggi penghalang Schottky
Pemindaian mikroskop elektron
Si nanowires
Scanning probe microscopy
bahan nano
Abstrak Array yang dipesan secara berkala dari kawat nano Si (Si NWs) yang disejajarkan secara vertikal berhasil dibuat dengan diameter dan panjang yang dapat dikontrol. Sifat fotokonduktif mereka diselidiki oleh mikroskop kekuatan atom fotokonduktif (PCAFM) pada kawat nano individu. Hasil peneliti
Logam secara tradisional menjadi bahan pilihan untuk banyak aplikasi karena sifat konduktifnya. Plastik rekayasa, bagaimanapun, telah berkembang pesat untuk memasukkan bahan yang bisa lebih ringan dan lebih keras dari logam dan juga dibuat untuk menghantarkan listrik. Karena itu, desainer produk men
Anda sudah tahu bahwa kami menyukai bahan pintar dan kali ini, kami ingin sedikit bercerita tentang tinta konduktif, bahan yang sangat menarik dengan manfaat yang besar. Apa itu tinta konduktif? Tinta konduktif adalah cat yang mengandung partikel perak atau karbon . Partikel ini bertanggung jawab
Ya dan tidak. PLA bukan konduktor listrik yang baik, tetapi akan menghantarkan arus kecil yang dapat menyebabkan masalah dengan elektronik. Konduktivitas berasal dari kotoran dalam bahan PLA, biasanya kelembaban. Kabar baiknya adalah sebagian besar filamen jauh di bawah tingkat konduktivitas dan