bahan nano








Konten Bi di GaAs/GaAs1 − x Bi x /GaAs heterostruktur yang ditumbuhkan oleh epitaksi berkas molekul pada suhu substrat mendekati 340 °C diselidiki dengan teknik medan gelap annular sudut tinggi yang dikoreksi aberasi. Analisis pada perbesaran rendah dari gambar mikroskop elektron transmisi pemindaian medan gelap annular sudut tinggi, dikuatkan oleh analisis EDX, mengungkapkan lapisan bebas cacat planar dan distribusi Bi yang tidak homogen pada antarmuka dan di dalam lapisan GaAsBi. Pada perbesaran tinggi, analisis qHAADF mengkonfirmasi distribusi tidak homogen dan pemisahan Bi pada antarmuka GaAsBi/GaAs pada fluks Bi rendah dan bentuk dumbbell terdistorsi di area dengan konten Bi lebih tinggi. Pada fluks Bi yang lebih tinggi, ukuran pengumpulan Bi meningkat yang mengarah ke partikel kaya Bi yang ekuaksial secara kasar disepanjang seng blende {111} dan tersebar merata di sekitar matriks dan antarmuka. Analisis FFT memeriksa koeksistensi dua fase dalam beberapa kluster:Bi murni rombohedral (rh-Bi) yang dikelilingi oleh campuran seng GaAs1 − x Bi x matriks. Cluster dapat memengaruhi relaksasi kisi lokal dan mengarah ke sistem GaAsBi/GaAs yang sebagian santai, sesuai dengan analisis XRD.
Saat ini, semikonduktor berbasis GaAsBi menarik minat sebagai perangkat yang stabil terhadap suhu dan inframerah tengah [1]. Menambahkan sejumlah kecil Bi ke dalam kisi GaAs menyebabkan pengurangan celah pita yang besar, menjadi salah satu efek optoelektronik yang paling menarik [2, 3]. Namun, memasukkan sejumlah kecil Bi ke dalam GaAs merupakan tantangan karena energi ikatan Ga-Bi yang lemah, kesenjangan miscibility yang besar, dan perbedaan besar dalam konstanta kisi antara GaBi dan GaAs. Akibatnya, GaAsBi harus tumbuh di bawah proses dinamis non-ekuilibrium untuk penggabungan Bi yang efisien. Meskipun meskipun berhasil disintesis, distribusi Bi terkadang tidak seragam, meningkatkan kepadatan pusat rekombinasi non-radiatif dan oleh karena itu mempengaruhi efisiensinya dalam operasi penguat. Ukuran besar dan elektronegativitas rendah Bi cenderung menghasilkan pemisahan fase [4], tetesan permukaan [5, 6], pemesanan atom [7,8,9], tetesan cairan skala nano [10] atau kluster Bi selama pertumbuhan epitaksi. Kehadiran cluster Bi sebelumnya terdeteksi oleh Ciatto et al. melalui kombinasi teknik spektroskopi serapan sinar-X (XAS), mikroskop gaya atom dan difraksi sinar-X (XRD) [11]. Kemudian, beberapa penulis melaporkan keberadaan kluster Bi dalam sampel GaAsBi anil dengan menggunakan teknik mikroskop elektron transmisi yang berbeda [4, 12, 13]. Selanjutnya, Kunzer et al. [14] dikonfirmasi oleh resonansi spin elektron konvensional (ESR) bahwa sekitar 10% dari Bi yang tergabung telah menempati situs Ga di lapisan GaAsBi. Oleh karena itu, pemahaman dan pengendalian penggabungan Bi dan pembentukan cacat sangat penting untuk keberhasilan penerapan GaAsBi ke perangkat. Perlu disebutkan bahwa pengembangan bahan berbasis Bi baru terkait dengan kemajuan alat karakterisasi. Dalam hal ini, teknik mikroskop elektron transmisi medan gelap annular sudut tinggi (HAADF-STEM) dalam mikroskop koreksi aberasi memainkan peran penting dalam memperoleh informasi pada tingkat sub-angstrom [15, 16]. Dalam teknik ini, intensitas dalam gambar secara kasar sebanding dengan nomor atom rata-rata (Z ) di kolom atom yang diproyeksikan, sehingga dapat berhasil diterapkan dalam heterostruktur Ga(AsBi) encer karena perbedaan besar dalam nomor atom Bi sehubungan dengan As dan Ga. Selain itu, fitur cerah pada gambar HAADF, bertentangan dengan mikroskop elektron transmisi resolusi tinggi (HRTEM), dapat dikaitkan dengan kolom atom dalam kristal selaras karena kurangnya pembalikan kontras dan delokalisasi. Juga, gambar HAADF yang dikoreksi penyimpangan dari sampel GaAsBi menunjukkan ketergantungan yang rendah pada ketebalan spesimen dan ketergantungan yang hampir linier pada komposisi As/Bi [12]. Selain itu, dengan menerapkan algoritma analisis citra kuantitatif HAADF (qHAADF), yang dikembangkan oleh Molina et al. [17], adalah mungkin untuk mengkorelasikan secara efektif intensitas HAADF dan komposisi kolom atom dalam bahan semikonduktor terner III-V [12, 16, 18] dan akibatnya dalam senyawa GaAsBi. Selain itu, gambar HAADF-STEM resolusi tinggi menawarkan informasi tentang kualitas kristal [19,20,21,22].
Dalam karya ini, kami menyelidiki melalui pencitraan HAADF-STEM yang dikoreksi penyimpangan dan sinar-X dispersi energi komplementer (EDX) distribusi Bi dalam GaAs/GaAs1 − x Bi x /GaAs heterostruktur yang ditumbuhkan dengan epitaksi berkas molekul (MBE) pada suhu substrat mendekati 340 °C. Kami juga mempelajari efek pengumpulan Bi pada skala nano dan mikro. Untuk tujuan ini, kami telah menggunakan pendekatan qHAADF, analisis Fourier fast transform (FFT) dari gambar resolusi tinggi dan teknik XRD.
Kami mempelajari serangkaian dua sampel yang terdiri dari GaAs/GaAs1 − x Bi x /GaAs heterostruktur yang ditumbuhkan oleh MBE sumber padat pada 2″ n + GaAs:Wafer Si (001) dengan fluks Bi berbeda yang diberikan oleh suhu sel Bi S1 (460 °C) dan S2 (505 °C). Sistem yang digunakan adalah mesin VG V80 MBE dengan rata-rata tekanan latar saat istirahat ~ 5 × 10 − 10 mbar. Struktur tersebut secara nominal terdiri dari buffer GaAs 130 nm, lapisan GaAsBi 130 nm, lapisan spacer GaAs 5 nm, dan penutup GaAs 130 nm. Sebelum pertumbuhan, substrat dikeluarkan pada suhu 400 °C selama 20 menit dan kemudian oksida permukaan dihilangkan pada suhu 600 °C. Buffer dan tutup GaAs ditanam pada ~ 580 °C di bawah As2 fluks, sedangkan lapisan GaAsBi dan lapisan pengatur jarak GaAs ditumbuhkan pada ~ 340 °C di bawah As4 yang hampir stoikiometrik aliran. Oleh karena itu, lapisan GaAsBi dianil in situ pada ~ 580 °C selama ~ 20 menit selama pertumbuhan tutup GaAs. Di bawah kondisi pertumbuhan ini, tidak ada tetesan logam di permukaan yang diamati. Suhu substrat diperkirakan menggunakan termometri optik, dengan hasil yang dikalibrasi terhadap transisi rekonstruksi permukaan pada suhu yang diketahui. Sebelum pertumbuhan GaAsBi, permukaan sampel terkena fluks Bi selama 20 dtk; tujuan dari langkah ini adalah untuk membentuk lapisan permukaan Bi dan meningkatkan penggabungan Bi pada awal pertumbuhan GaAsBi.
Spesimen untuk HAADF-STEM disiapkan dalam penampang dengan penggilingan mekanis dan Ar + penggilingan ion menggunakan sistem pemolesan ion presisi (PIPS), dengan kemiringan sinar 3° dan + 4° dan energi sinar antara 2,8 dan 3,0 kV. Pada langkah penggilingan terakhir, energi ion diturunkan menjadi 1,5 kV untuk meningkatkan kualitas permukaan. Sampel sebelum dipelajari dibersihkan dengan plasma untuk mengurangi efek deposisi berkas elektron pada permukaan spesimen [23]. Gambar HAADF-STEM, spektrum kehilangan energi elektron tanpa kehilangan energi (EELS), dan pemindaian garis spektrum sinar-X dispersif energi dilakukan pada 200 kV, menggunakan Titan 3 Themis pada 60–300 kV. Sang Titan 3 Themis dilengkapi dengan cold field emission gun (FEG), korektor probe Cs dan monokromator elektron, yang memungkinkan resolusi atom dalam pencitraan HAADF. Mikroskop ini juga mencakup detektor EDX quad Super-X untuk analisis unsur, memberikan informasi tentang posisi dan komposisi atom secara bersamaan. Gambar elektron sekunder (SE) untuk studi topografi spesimen TEM dilakukan menggunakan mikroskop FEI NOVA NANOSEM 450 pada 2 kV.
Garis Bi-M pada 2,42 keV digunakan untuk penentuan kuantitatif komposisi Bi melalui perangkat lunak Bruker Espirit. Ketebalan spesimen ditentukan dari analisis sinyal EELS zero-loss yang diselesaikan secara spasial, dengan menggunakan perangkat lunak Digital Micrograph (GATAN™) [23]. Distribusi Bi kolom demi kolom telah dipelajari menggunakan perangkat lunak qHAADF yang tersedia untuk dijalankan pada Mikrograf Digital. Perangkat lunak ini memungkinkan pengukuran dan pemetaan intensitas terintegrasi dari area terpilih di sekitar kolom atom dengan mendeteksi puncak intensitas pada citra HAADF-STEM [17]. Spektrum -2θ (0 0 4) XRD diukur dengan difraktometer sinar-X Bruker D8 Discover menggunakan Cu-Kα1 radiasi. Pemindaian disimulasikan menggunakan perangkat lunak Bede Rads Mercury.
Gambar 1 menunjukkan gambar HAADF-STEM perbesaran rendah yang diambil pada sumbu zona [110] sampel S1 (a) dan S2 (b), bersama dengan profil intensitas koreksi gradien ketebalan yang diambil di sepanjang arah [001] dari wilayah yang ditandai di gambar HAADF-STEM (persegi panjang hijau). Tidak ada dislokasi ulir atau kesalahan susun yang terdeteksi di wilayah yang dipelajari dari kedua sampel. Dalam HAADF, intensitas yang diperoleh sebanding dengan nomor atom rata-rata. Jadi, untuk ketebalan sampel yang konstan, kontras yang lebih cerah pada gambar terkait dengan konten Bi yang lebih tinggi (Z Dua = 83, Z Ga = 31 dan Z Sebagai = 33). Hal ini memungkinkan studi distribusi Bi dalam heterostruktur GaAsBi/GaAs. Seperti yang dapat diamati pada Gambar 1a, tidak ada variasi kontras yang jelas yang terdeteksi pada lapisan GaAsBi dalam sampel S1—dengan konten Bi yang lebih rendah—tidak menunjukkan bukti pengelompokan yang jelas, bahkan di area lain dengan ketebalan sampel yang lebih tinggi. Namun, kluster Bi dan As telah dilaporkan dalam literatur, bahkan untuk sampel GaAsBi dengan kandungan Bi serendah 1,44%, meskipun tumbuh pada suhu yang lebih rendah [11]. Berkenaan dengan sampel S2, dengan konten Bi yang lebih tinggi, Gambar 1b menggambarkan beberapa area dengan kontras yang lebih cerah pada lapisan dengan ukuran dan distribusi yang relatif homogen. Wilayah ini, yang didistribusikan secara teratur di sepanjang lapisan dan antarmuka GaAsBi, dapat langsung ditafsirkan sebagai kluster yang mengandung Bi karena intensitas HAADFnya yang lebih tinggi. Untuk visualisasi yang lebih baik, gambar yang difilter low-pass yang sesuai ditampilkan sebagai sisipan pada gambar yang sama, di mana warna kuning sesuai dengan area konten Bi yang lebih tinggi dan hitam ke yang lebih rendah (skala suhu). Pembentukan cluster Bi di GaAsBi tanpa memprovokasi cacat struktural sebelumnya telah dilaporkan oleh penulis lain [7, 24, 25]. Integrasi Bi (1,6 kali volume atom As) dalam matriks GaAs dapat menyebabkan peningkatan energi substitusi karena regangan, mengurangi kelarutan atom As dan memungkinkan berkumpulnya atom Bi. Sebuah studi sampel menggunakan mikroskop elektron pemindaian pistol emisi lapangan (FEG-SEM) dilakukan untuk memastikan bahwa kluster Bi tertanam di dalam lapisan. Untuk tujuan itu, gambar topografi elektron sekunder yang diperoleh pada tegangan rendah (tidak ditampilkan di sini) dibandingkan dengan gambar STEM yang diambil dari area yang sama.

a Gambar penampang HAADF-STEM sampel S1 menunjukkan antarmuka GaAs/GaAsBi/GaAs. b Gambar penampang HAADF-STEM sampel S2, di lapisan GaAsBi titik terang yang didistribusikan di sepanjang lapisan GaAsBi yang terkait dengan area kaya Bi diamati. Detail menggunakan skala warna suhu suatu area setelah menerapkan filter lolos rendah disertakan sebagai sisipan dalam gambar yang sama untuk visualisasi yang lebih baik. c Profil intensitas koreksi gradien ketebalan yang diambil di sepanjang arah [001] dari daerah yang ditandai dengan persegi panjang hijau pada gambar HAADF-STEM, garis biru untuk sampel S1 dan garis hitam untuk sampel S2, menunjukkan perilaku yang sedikit berbeda pada antarmuka
Untuk mendapatkan informasi lebih lanjut tentang distribusi Bi dalam sampel, profil intensitas sepanjang arah pertumbuhan dengan gradien ketebalan terkoreksi ditunjukkan pada Gambar. 1c. Profil, diambil dari gambar HAADF-STEM pada Gambar. 1a, b, menunjukkan perilaku serupa di kedua sampel:antarmuka yang kasar, lapisan GaAsBi dengan panjang yang sama (~ 140 nm). Mengenai antarmuka GaAsBi/GaAs, intensitas HAADF turun dari nilai maksimumnya menjadi ~ 0 dalam sekitar 10 nm (lihat persegi panjang putus-putus abu-abu di profil), menunjukkan beberapa penggabungan Bi di seluruh lapisan penutup GaAs bahkan tanpa fluks Bi. Profil juga menggambarkan informasi tentang waktu ekuilibrasi. Seperti yang dapat diamati dari profil, dalam sampel konten Bi yang lebih rendah (S1), antarmuka GaAs/GaAsBi lebih mendadak daripada sampel konten Bi yang lebih tinggi (S2). Hal ini dapat dijelaskan oleh koefisien penggabungan Bi yang berbeda dari dua sampel. S1, ketika ditumbuhkan pada suhu yang sama dengan S2, memiliki kandungan Bi yang jauh lebih kecil. S1 karena itu mungkin tumbuh di bawah kondisi kinetik terbatas dengan penggabungan dekat-kesatuan Bi [26], yang berarti bahwa lapisan permukaan Bi akan menyeimbangkan selama kerangka waktu kurang dari permukaan seumur hidup atom Bi pada suhu ini. S2, di sisi lain, mungkin memiliki koefisien penggabungan Bi yang lebih rendah [27]. Lapisan permukaan Bi dalam kasus ini akan membutuhkan lebih dari masa hidup permukaan atom Bi untuk menyeimbangkan, yang mengarah ke stabilisasi penggabungan Bi yang lebih lambat.
Untuk mengkonfirmasi korelasi yang dibuat antara profil intensitas HAADF-STEM dan distribusi Bi dalam heterostruktur, peta komposisi STEM-EDX Bi dari sampel diambil secara bersamaan. Mereka ditunjukkan pada Gambar. 2 untuk sampel pada fluks Bi rendah (a) dan tinggi (b). Profil komposisi Bi yang sesuai di sepanjang arah pertumbuhan, ditentukan dengan mengintegrasikan spektrum titik EDX dari area sekitar 130 nm, masing-masing ditunjukkan pada Gambar 2c sebagai garis biru dan hitam. Profil komposisi ini menampilkan kecenderungan yang sama yang terdeteksi di antarmuka GaAs/GaAsBi/GaAs dengan analisis HAADF perbesaran rendah. Fraksi atom Bi rata-rata dalam lapisan GaAsBi dihitung dari spektrum EDX yang sesuai menjadi 1,2 ± 0,4% dan 5,3 ± 0,4% dalam sampel S1 dan S2, masing-masing, menunjukkan distribusi Bi yang tidak homogen di lapisan GaAsBi di kedua sampel .

Peta elemen STEM/EDX yang mewakili distribusi Bi dalam sampel S1 (a ) dan S2 (b ). Detail peta unsur Bi, Ga dan As yang sesuai dengan cluster yang ditandai dengan persegi panjang putih pada Gambar 1b mengungkapkan penurunan sinyal As dan Ga di mana terdapat wilayah Bi yang tinggi. c Profil konten bi di sepanjang arah [001] diekstraksi setelah integrasi area sekitar 130 nm dari peta EDX sampel S1 (garis biru) dan S2 (garis hitam). Fitur serupa diamati pada profil intensitas pada perbesaran rendah yang ditunjukkan pada Gambar. 1c
Kehadiran kluster Bi akan disebabkan oleh efek penghalang sterik. Dalam hal ini, tegangan permukaan dapat meningkat karena ukuran atom yang lebih besar dari atom Bi, sehingga untuk mengurangi tegangan pada struktur, atom Bi dapat menghalangi penggabungan Ga dan akibatnya menyebabkan kekosongan Ga dalam jaring. Peta komposisi Ga dan As dari cluster yang dikelilingi oleh kotak putih pada Gambar 2b disertakan untuk menunjukkan bagaimana kedua sinyal jatuh di tempat yang memiliki sinyal Bi tinggi. Ini menunjukkan bahwa, dalam kluster khusus ini, Bi dapat menempati sub-kisi grup III dan grup V. Ini juga membuktikan bahwa kluster bukanlah kluster yang terbentuk selama preparasi sampel TEM.
Untuk melakukan studi mendalam tentang distribusi Bi pada tingkat atom, gambar HAADF-STEM dengan koreksi aberasi perbesaran tinggi diambil dalam proyeksi [110]. Dalam paduan semikonduktor III-V ini, dua puncak intensitas maksimum halter sesuai dengan kolom atom grup III dan grup V. Untuk mengkorelasikan intensitas kolom atom dengan komposisinya dengan benar, tingkat latar belakang telah dihapus dari gambar HAADF-STEM eksperimental. Kemudian, lokasi otomatis dari puncak intensitas telah dilakukan, dan area integrasi di sekitar kolom atom grup V dipilih dengan cermat. Intensitas terintegrasi diukur dan dipetakan untuk setiap dumbbell menggunakan pendekatan qHAADF. Prosedur untuk mengukur konten Bi mirip dengan yang diterbitkan di Ref. [28]. Dalam karya ini, hasil bagi intensitas terintegrasi dari setiap dumbbell (R ) dihitung sebagai rasio antara intensitas terpadu dalam kolom grup V (I As − Bi ) di seluruh gambar dan intensitas terintegrasi rata-rata dalam kolom grup V di lapisan GaAs (I Sebagai ), sebagai R = (Aku (As − Bi) )/Saya Sebagai .
Gambar 3a menunjukkan gambar HAADF-STEM perbesaran tinggi dari antarmuka GaAs/GaAsBi yang diambil dari sampel dengan konten Bi (S1) yang buruk. Peta intensitas terintegrasi yang dinormalisasi berwarna dari gambar HAADF ditunjukkan pada Gambar. 3b. Titik-titik berwarna mulai dari 1 (biru tua) hingga 1,27 (merah) menggambarkan konten Bi di kolom grup V. Seperti yang dapat diamati, fluktuasi kecil di R nilai dari nilai rata-rata ditemukan di kedua lapisan. Untuk membandingkan dispersi dari hasil yang diperoleh, kami telah menghitung koefisien korelasi Cv (didefinisikan sebagai rasio antara simpangan baku dan rata-rata R nilai) di GaAs (substrat), lapisan GaAsBi dan lapisan tutup GaAs. Cv nilai masing-masing adalah 1,3, 2,6 dan 2,6%, karena fluktuasi yang diamati pada antarmuka GaAsBi/GaAs lebih tinggi daripada yang ditemukan dalam substrat GaAs yang diambil sebagai referensi; kita dapat menganggap bahwa variasi ini dalam R nilai terkait dengan perubahan komposisi kolom Bi. Penyebab tidak nol Cv faktor dalam substrat mungkin karena fluktuasi ketebalan lokal, kebisingan detektor (diukur di wilayah tanpa bahan sebagai 0,6%) atau hidrokarbon yang diendapkan pada sampel permukaan selama karakterisasi mikroskop.

a Penampang [110] gambar HAADF-STEM dari antarmuka GaAsBi/GaAs sampel S1. Detail daerah yang tidak terdistorsi di lapisan GaAs dan dumbel anion-kation yang terdistorsi di area kaya Bi pada perbesaran lebih tinggi disertakan sebagai sisipan pada gambar yang sama. b Peta berwarna mewakili R nilai di sekitar kolom grup V dari gambar HAADF pada Gambar. 3a. Warna hijau sesuai dengan komposisi Bi rata-rata pada lapisan GaAsBi yang diukur dengan EDX. Meskipun distribusi Bi dalam gambar HAADF-STEM homogen, peta intensitas menunjukkan area dengan probabilitas tinggi pengelompokan nano (titik merah) dan kolom dengan konten Bi yang relatif buruk (titik biru) di lapisan GaAsBi. c Profil sepanjang arah pertumbuhan seluruh R peta intensitas, menampilkan antarmuka GaAsBi/GaAs yang kabur dalam jarak sekitar 10 nm
Analisis qHAADF ini mengkonfirmasi antarmuka GaAsBi/GaAs atas yang tidak tiba-tiba lebih dari sekitar 10 nm yang dirasakan pada perbesaran rendah, terutama karena segregasi permukaan Bi selama pertumbuhan, karena dapat diamati dari profil yang diambil di sepanjang arah pertumbuhan di seluruh intensitas R peta, ditunjukkan pada Gambar. 3c. Selanjutnya, kolom kaya Bi yang tersebar di dalam lapisan GaAsBi (titik merah), bersama dengan area dengan konten Bi yang buruk (titik biru) di lapisan GaAsBi, juga terdeteksi dengan perangkat lunak ini, yang mengonfirmasi fluktuasi konten Bi di lapisan GaAsBi . Kehadiran kolom kaya-Bi tampaknya menghasilkan distorsi yang berbeda dalam bentuk halter karena dapat diapresiasi di sisipan pada perbesaran yang lebih tinggi pada Gambar. 3a. Substitusi atom As untuk atom Bi yang lebih besar selama pertumbuhan epitaksial akan memperluas kisi matriks secara lokal, menyebabkan distorsi pada bentuk halter sementara struktur dipertahankan.
Teknik HAADF-STEM juga memungkinkan analisis struktural dan komposisi gugus yang terdeteksi pada perbesaran rendah dalam sampel S2. Cluster ini, hampir terdistribusi secara homogen, menempati sekitar 20-30% dari permukaan lapisan GaAsBi. Untuk mengetahui komposisi Bi, bentuk dan ukuran cluster yang ditemukan, gambar HAADF-STEM yang dikoreksi aberasi diambil pada proyeksi [110] dan peta elemen EDX dan rasio peta intensitas di sekitar kolom grup V dilakukan. Untuk mengidentifikasi fase kristal yang berbeda, studi transformasi Fourier cepat (FFT) dilakukan pada gambar resolusi tinggi di berbagai area di dalam dan di sekitar cluster.
Gambar 4a menunjukkan gambar HAADF-STEM resolusi tinggi [110] dari antarmuka GaAsBi/GaAs dengan kluster Bi yang jelas dengan diameter sekitar 12 nm. Persegi panjang merah pada gambar mewakili area di mana studi FFT dilakukan. Telah diketahui dengan baik bahwa pemfilteran low-pass tidak hanya mengurangi jumlah noise dalam data, tetapi juga menghilangkan fitur periodik yang diamati pada gambar mentah, yang menekankan tepi cluster Bi. Gambar HAADF-STEM yang difilter, mengikuti prosedur yang dijelaskan oleh Werner et al. [29], ditunjukkan pada Gambar. 4b. Seperti yang dapat diapresiasi, {111} dan (001) segi di area paling terang dapat diamati dengan jelas. Namun, distribusi intensitas menunjukkan adanya dua volume komposisi yang berbeda dalam partikel:yang kaya Bi dengan bentuk trapesium yang dikelilingi oleh area yang kurang kaya Bi. Bentuk cluster serupa diamati untuk Wood et al. dalam GaA lima periode1 − x Bi x /GaAs1 − y Bi y struktur [10].
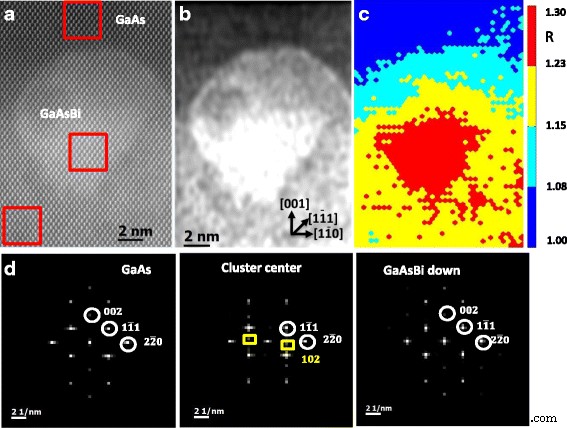
a Gambar penampang [110] HAADF-STEM antarmuka GaAsBi/GaAs sampel S2, menangkap kluster Bi berukuran sekitar 12 nm, di samping antarmuka GaAsBi/GaAs. b Gambar dengan filter rendah dari gambar HAADF-STEM menunjukkan dua area dengan kontras yang berbeda di lapisan GaAsBi, zona kaya-Bi disepanjang bidang {111} dan (001), dikelilingi oleh bidang kaya-Bi yang lebih rendah. c Peta berwarna mewakili R nilai di sekitar kolom grup V yang menggambarkan distribusi Bi bergradasi di sekitar cluster. d Transformasi Fourier yang sesuai dari area terpilih yang ditandai dengan persegi panjang merah pada Gambar 1a. Bintik-bintik tambahan yang cocok dengan {102} bidang yang terkait dengan fase rh-Bi terdeteksi di wilayah cluster kontras tertinggi
Analisis qHAADF melalui intensitas R peta yang ditunjukkan pada Gambar. 4c menggambarkan bentuk partikel ekiaksial secara kasar dan gradien konsentrasi Bi memuncak di tengah cluster.
Wu dkk. [4] melaporkan adanya struktur kristalografi yang berbeda dalam lapisan GaAsBi mempelajari mikrograf HRTEM dan pemodelan pembentukan dan transformasi fase dari seng blende Bi-kaya ke rhombohedral Bi (rh-Bi) berinti di zinc blende {111} pesawat. Dalam pengertian ini, perlu disebutkan bahwa titik terang dalam FFT dari gambar HAADF-STEM resolusi tinggi dapat diinterpretasikan sebagai titik difraksi dari bidang kristalografi. Kemudian, bintik-bintik ekstra dalam pola konvensional untuk struktur campuran seng dari GaAs harus ditafsirkan sebagai fase tambahan. Untuk mempelajari keberadaan struktur kristal yang berbeda dalam cluster, Gambar 4d menunjukkan FFT yang sesuai dengan tiga area berbeda yang ditandai sebagai kotak merah pada Gambar 1a. Dari kanan ke kiri menunjukkan daerah homogen pada lapisan tutup GaAs, zona paling terang pada lapisan GaAsBi dan daerah lain dengan kontras lebih rendah pada lapisan GaAsBi yang sama. Lingkaran putih menunjukkan posisi puncak difraksi dengan indeks Miller 002, \( 1\overline{1}1 \) dan\( 2\overline{2}0 \). Seperti yang dapat diamati, hanya di tengah gugus muncul bintik-bintik yang jelas, ditandai dengan kotak kuning, terkait dengan bidang {102} yang kira-kira sejajar dengan bidang campuran seng {220}, menunjukkan bahwa fase rh-Bi baru telah berinti di lapisan campuran seng GaAsBi. FFT juga menggambarkan pelebaran puncak difraksi yang terkait dengan bidang {111}. Puncak asimetris yang diamati ini mungkin disebabkan oleh penyebab regangan mikro dengan menggeser bidang {111} antara fase rh-Bi dan zinc blende dalam cluster.
Untuk studi mendalam tentang komposisi cluster, perlu disebutkan bahwa ketika elektron melewati spesimen transparan elektron dengan cluster tertanam, mereka membawa informasi tidak hanya tentang cluster, tetapi juga dari matriks. Jadi, untuk memperkirakan komposisi cluster nyata, kami mengikuti prosedur yang sama yang dijelaskan dalam Ref. [25]. Hasil juga menunjukkan bahwa cluster yang dekat dengan antarmuka GaAsBi/GaAs cenderung berukuran lebih kecil (12 nm) dengan konten Bi yang lebih tinggi (≈ 30%), mungkin karena keberadaan Bi di permukaan saat lapisan penutup mulai ditumbuhkan. Namun, sebagian besar cluster yang terletak di dalam lapisan GaAsBi memiliki ukuran yang lebih besar (16 nm), tetapi konten Bi-nya lebih rendah (≈ 22%). Selain itu, di lapisan GaAsBi, kluster dengan konten Bi superior (35%) dan ukuran lebih tinggi (23 nm) terdeteksi. Selain itu, seperti yang telah disebutkan sebelumnya, inti dari beberapa cluster terdiri dari rh-Bi murni.
Untuk menyelidiki keadaan regangan film epitaksi, kurva sinar-X resolusi tinggi -2θ direkam. Gambar 5 menunjukkan pemindaian XRD (004) dari lapisan GaAsBi/GaAs dengan warna biru dan kecocokan simulasi dalam warna oranye untuk sampel S1 (a) dan S2 (b). Dalam kedua sampel, puncak intensitas paling tajam dan tertinggi yang terletak pada detik busur 0 ° sesuai dengan substrat GaAs, sedangkan puncak intensitas rendah yang luas yang terletak pada detik busur negatif sesuai dengan lapisan GaAsBi yang tegang. Sudut antara puncak berhubungan dengan jumlah ketidakcocokan kisi antara kedua lapisan. Bahu di sebelah kanan puncak GaAs dalam spektrum S2 menunjukkan lapisan GaAs di bawah regangan tarik; ini menyiratkan relaksasi regangan di lapisan S2 GaAsBi. Spektrum XRD sampel S1 dipasang dengan baik menggunakan fraksi Bi dan ketebalan yang diberikan oleh pengukuran EDX dan HAADF. Tidak ada indikasi relaksasi regangan dalam spektrum XRD sampel S1. Spektrum XRD sampel S2 lebih bermasalah untuk dicocokkan. Gambar 5b menunjukkan data yang dimodelkan oleh lapisan GaAsBi seragam sebesar 5,8%, sebagaimana ditentukan oleh analisis HAADF-STEM, mengabaikan kluster kaya Bi, dan relaksasi lapisan GaAsBi sebesar 6%, sebagaimana ditentukan dengan menyesuaikan kurva XRD; ini akan masuk akal jika cluster tidak koheren dengan sisa matriks GaAsBi. Model ini tidak secara akurat mewakili lapisan; sementara pemisahan substrat-GaAsBi cukup untuk memperhitungkan data, tidak ada puncak GaAs tarik pada ~ 250 ° detik busur yang terlihat. Puncak GaAs tarik menunjukkan bahwa relaksasi telah terjadi di dalam lapisan. Relaksasi lapisan tekan akan mengurangi konstanta kisi luar bidang, yang menyiratkan bahwa rata-rata kandungan Bi yang dimodelkan sebesar 5,8% merupakan perkiraan yang terlalu rendah dari rata-rata yang sebenarnya; ini konsisten dengan pengamatan cluster Bi-kaya di lapisan. Tidak ada puncak yang sesuai dengan ~ 22–35% GaAsBi yang diamati oleh pemetaan ruang timbal balik (tidak ditampilkan), yang menunjukkan bahwa kluster mungkin tidak koheren dengan matriks GaAsBi. Tidak ada pemodelan lebih lanjut dari spektrum S2 XRD yang dicoba.

Data difraksi sinar-X (garis biru) dan kecocokan simulasi (garis oranye) sampel S1 (a ) dan sampel S2 (b ). Garis putus-putus vertikal menyoroti puncak GaAs pada detik busur 0° dan puncak film GaAsBi terletak pada detik busur negatif. Bahu di puncak GaAs kanan pada Gambar. 5b menunjukkan lapisan penutup GaAs di bawah regangan tarik
Analisis ac-HAADF-STEM menawarkan informasi yang berguna tentang struktur dan komposisi heterostruktur GaAs/GaAsBi/GaAs, hasilnya sesuai dengan investigasi EDX, FFT, dan XRD. Analisis gambar HAADF-STEM perbesaran rendah memungkinkan pendeteksian distribusi Bi yang tidak homogen dan antarmuka GaAsBi/GaAs yang tidak tiba-tiba. Pada perbesaran tinggi, analisis qHAADF mengungkapkan pemisahan Bi yang jelas pada antarmuka GaAsBi/GaAs pada fluks Bi rendah (S1), dan bentuk halter terdistorsi di area dengan fraksi Bi yang lebih tinggi, karena posisi substitusi As dari atom Bi dalam subnet grup V . Pada fluks Bi (S2) yang lebih tinggi, ukuran pengumpulan Bi meningkat yang mengarah ke kluster ekuaksial kasar yang tersebar merata di sekitar seluruh matriks dan antarmuka. Studi ini mengungkapkan koeksistensi dua fase kristal yang berbeda dalam kluster yang dipelajari bidang rh-Bi dan zink blende geser {111}, yang mempengaruhi relaksasi kisi lokal dan mengarah ke sistem GaAsBi / GaAs yang sebagian santai, sesuai dengan analisis XRD.
Mikroskop elektron transmisi medan gelap annular sudut tinggi yang dikoreksi penyimpangan
Sinar-X dispersi energi
Spektrum kehilangan energi elektron
Resonansi spin elektron konvensional
Pistol emisi medan dingin
Transformasi cepat Fourier
Mikroskop elektron transmisi resolusi tinggi
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
Epitaksi berkas molekul
Algoritme analisis gambar HAADF kuantitatif
Pemindaian mikroskop elektron
Spektroskopi serapan sinar-X
difraksi sinar-X
bahan nano
Pengembangan produk adalah proses yang terus berkembang, dan Anda mungkin tidak melakukannya dengan benar pada percobaan pertama. Jangan khawatir - sejumlah ini diharapkan. Jika dan ketika suatu bagian gagal atau tidak berfungsi seperti yang diharapkan, Anda ingin mencari tahu sebanyak mungkin tenta
Analisis operasi adalah prosedur yang digunakan untuk menentukan efisiensi berbagai aspek operasi bisnis. Sebagian besar laporan mencakup pemeriksaan yang cermat terhadap metode produksi perusahaan, biaya material, implementasi peralatan, dan kondisi tempat kerja. Konsultan profesional sering didata
Papan distribusi adalah panel atau selungkup yang menampung sekering, pemutus sirkuit, dan unit pelindung kebocoran arde yang digunakan untuk mendistribusikan daya listrik ke berbagai sirkuit individu atau titik konsumen. Papan biasanya memiliki satu sumber daya masuk dan termasuk pemutus sirkuit ut
Atau disebut sebagai papan distribusi, papan panel adalah elemen dari sistem yang digunakan untuk memasok listrik. Fungsi utamanya adalah untuk membagi umpan listrik ke sirkuit tambahan sambil menyediakan pelindung atau sekering pelindung untuk setiap sirkuit di ruang tertutup. Panel dan papan distr