Faktor yang Mempengaruhi Kualitas Perakitan BGA
Seiring dengan perkembangan pesat sirkuit terpadu (IC) skala sangat besar, permintaan perakitan elektronik tidak pernah dapat dipenuhi oleh jenis paket tradisional dan paket yang lebih baru muncul karena dorongan tuntutan dalam hal integritas yang lebih tinggi, ukuran papan yang lebih kecil dan I yang lebih tinggi. /O hitungan. Di antara semua jenis paket terbaru yang disebutkan di atas, paket BGA (ball grid array) adalah jenis utama dengan bidang aplikasi terluas karena keragamannya yang mengalahkan berbagai keterbatasan yang ditampilkan oleh paket tradisional. Dilihat dari unsur-unsur teknologi penyolderan, paket BGA hampir tidak berbeda dengan paket tradisional, QFP (paket quad flat) misalnya. Namun demikian, pin digantikan oleh bola solder, yang dapat dianggap sebagai revolusi dalam perakitan elektronik dan mendorong munculnya paket turunan seperti CSP (paket skala chip). Saat ini, penyolderan BGA masih diterapkan dengan penerapan teknologi SMT (surface mount technology) tradisional dan penyolderan BGA masih dapat dilakukan pada peralatan perakitan SMT biasa. Artikel ini akan membahas beberapa faktor yang mempengaruhi penerapan teknologi perakitan BGA termasuk desain pad BGA, pencetakan pasta solder, akurasi penyelarasan pemasangan, kurva suhu penyolderan, dan cacat penyolderan.
Kelayakan Desain BGA Pad
Paket BGA datang dalam beberapa klasifikasi berdasarkan nada yang berbeda. Secara umum, desain pad BGA harus mempertimbangkan kelayakan penelusuran CAD dan manufaktur PCB (papan sirkuit tercetak) sebagai pertimbangan awal. BGA pad juga tersedia dalam berbagai jenis dan dapat dipilih secara bebas bila ruang memungkinkan dengan jenis berikut yang biasa digunakan.
• Bantalan Tulang Anjing
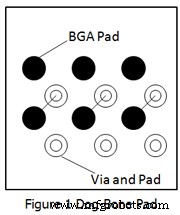
Bantalan tulang anjing memanfaatkan via untuk mengarahkan jejak ke lapisan lain sehingga beberapa batasan telah ditetapkan untuk ukuran bantalan. Karena adanya vias, beberapa cacat cenderung disebabkan selama proses pembuatan PCB seperti jembatan penyolderan karena topeng solder jatuh. Oleh karena itu, ukuran bantalan harus dirancang dengan benar-benar sesuai dengan tingkat manufaktur praktis untuk meminimalkan cacat penyolderan yang dihasilkan selama penyolderan BGA dan menyisakan ruang untuk pengerjaan ulang BGA di masa mendatang.
• Via Didistribusikan Secara Eksternal ke BGA Pads
Jenis pad ini bekerja paling baik untuk komponen BGA dengan jumlah I/O yang rendah. Jenis desain bantalan ini memberikan kemudahan untuk menyolder dan menetapkan lebih banyak ruang kosong untuk ukuran bantalan. Tentu saja, persyaratan mendasar harus dipenuhi dalam hal penelusuran. Dengan demikian, hampir tidak mungkin untuk memanfaatkan jenis pad ini pada BGA dengan jumlah I/O yang lebih tinggi.
• Pad Via-in-pad
Via in pad berkembang seiring dengan kemajuan teknologi microvia dalam fabrikasi PCB.
Terlepas dari jenis bantalan, topeng solder dan posisi bantalan BGA berhubungan langsung dengan penyolderan BGA. Berdasarkan posisi topeng solder yang berbeda, bantalan BGA datang dalam dua jenis:bantalan SMD (masker solder ditentukan) dan bantalan NSMD (tidak ditentukan topeng solder) dengan fungsi masing-masing pada penyolderan BGA. Saat bantalan SMD diterapkan, bantalan memiliki area ikatan yang besar dengan bantalan, yang mengarah ke area ikatan yang sama besar antara sambungan solder dan papan PCB. Namun, seiring bertambahnya ukuran bantalan, jarak antara bantalan yang berdekatan menjadi kecil, yang memengaruhi melalui distribusi bantalan dan kemampuan penelusuran.
Selama prosedur fabrikasi PCB, jika topeng solder menyimpang di sepanjang arah yang sama, pad BGA tidak akan terpengaruh, yang bermanfaat untuk penyolderan BGA. Tapi jenis pad ini cenderung rusak selama pengerjaan ulang topeng solder di tepinya, yang buruk untuk efek pengerjaan ulang. Setelah pad NSMD digunakan, pad akan relatif kecil, yang bermanfaat melalui distribusi dan penelusuran pad. Jenis struktur bantalan ini, bagaimanapun, menghasilkan penurunan area ikatan antara sambungan solder dan bantalan dan selanjutnya mengurangi intensitas ikatan sambungan solder. Singkatnya, kedua pad memiliki kelebihan dan kekurangan masing-masing dan pad yang sesuai dapat ditentukan berdasarkan pertimbangan teknologi.
Pencetakan Tempel Solder
Pencetakan pasta solder memainkan peran penting dalam menentukan kualitas penyolderan. Pencetakan pasta solder adalah transformasi akurat pasta solder dari stensil ke pad dengan stensil, pasta solder, dan printer yang terlibat. Presisi printer pasta solder pertama-tama harus sesuai dengan tuntutan perakitan BGA. Stensil menentukan jumlah pasta solder melalui ketebalan dan ukuran pembukaannya. Jumlah pasta solder yang disebut oleh paket BGA biasanya ditentukan oleh 3 aspek:
• Solder yang cukup harus digunakan untuk memastikan koneksi solder BGA yang sangat baik.
• Jumlah pasta solder harus mengkompensasi kesalahan co-planarity bola solder (biasanya 0,1 mm) dari komponen BGA.
• Ketika komponen fine-pitch lainnya tersedia di papan sirkuit, jumlah pasta solder harus dipertimbangkan secara komprehensif untuk menghentikan lebih banyak kerusakan solder yang terjadi.
Akurasi Pemosisian
Posisi akurat komponen BGA pada papan sirkuit sepenuhnya bergantung pada presisi pemasangan chip yang sebagian besar berisi sistem pemosisian khusus yang mampu membantu mencapai pemosisian komponen BGA yang akurat. Selain itu, beberapa chip mount bahkan dapat memeriksa bola solder BGA dalam hal keselarasannya dan mengenali beberapa cacat seperti bola yang hilang, yang sangat membantu untuk meningkatkan keandalan penyolderan BGA.
Selanjutnya, beberapa tindakan lain dapat dilakukan untuk lebih meningkatkan akurasi pemasangan komponen BGA dan. Misalnya, tanda fidusia lokal ditetapkan di bagian luar bantalan BGA atau beberapa garis lipatan ditetapkan sebagai tanda fidusia untuk inspeksi manual setelah perakitan, keduanya telah diverifikasi efektif dalam pembuatan praktis.
Selain itu, komponen BGA memiliki efek pemusatan otomatis yang jelas dalam proses penyolderan karena tegangan permukaan solder sehingga beberapa desainer dengan sengaja memperbesar bantalan di keempat sudut dalam desain bantalan BGA, membuat efek pemusatan diri lebih jelas untuk memastikan komponen BGA dapat reset sendiri saat posisi pemasangan digeser.
Kurva Suhu Solder dan Cacat Solder
Kurva suhu penyolderan secara langsung menentukan kualitas penyolderan. Kurva suhu biasanya mencakup empat fase:fase pemanasan awal, fase perendaman, fase reflow dan fase pendinginan yang masing-masing menampilkan perubahan fisik/kimia yang berbeda. Karena pengaturan kurva suhu menentukan proses pembentukan sambungan solder, ia memiliki hubungan yang erat dengan keandalan sambungan solder. Karena kekhasan paket BGA, sangat sulit untuk menghasilkan kurva suhu yang memuaskan. Secara umum, komponen BGA memerlukan tiga suhu untuk diukur:suhu pengemasan, suhu permukaan papan sirkuit, dan suhu sambungan solder internal BGA.
Teknologi Pemeriksaan dan Pengerjaan Ulang BGA
Karena semua sambungan solder BGA berada di bawah paket setelah penyolderan, metode inspeksi tradisional seperti uji probe terbang atau inspeksi visual gagal memenuhi kebutuhan praktis. Hingga kini, mereka memimpin metode yang dapat memindai cacat penyolderan sambungan solder BGA adalah uji AOI (pemeriksaan optik otomatis) dan uji AXI (pemeriksaan sinar-X otomatis).
Berdasarkan sifat struktur BGA, hampir tidak mungkin untuk memeriksa satu sambungan solder komponen BGA. Namun, badan kemasan yang lengkap harus dikerjakan ulang.
Faktor Lain
Faktor lain yang harus diperhatikan dalam proses perakitan BGA seperti perlindungan elektrostatik dan pemanggangan komponen BGA. Biasanya, komponen BGA membutuhkan paket khusus dengan persyaratan perlindungan elektrostatik. Selama proses perakitan papan sirkuit tercetak, tindakan perlindungan elektrostatik yang ketat harus dilakukan termasuk grounding peralatan, manajemen staf, dan administrasi lingkungan.
Perakitan BGA dengan Harga Bagus
Dengan pengalaman lebih dari sepuluh tahun menangani permintaan Perakitan PCB dari klien di seluruh dunia, kami memiliki kemampuan untuk menyolder hampir semua jenis suku cadang ke papan sirkuit, termasuk komponen BGA. Jika Anda memiliki pertanyaan atau masalah tentang Perakitan PCB, hubungi kami untuk mengetahui tentang kemampuan solder PCB kami dan diskusikan proyek populasi PCB khusus. Jangan ragu untuk mengklik tombol di bawah ini untuk meminta Harga Perakitan BGA! Ini BENAR-BENAR GRATIS!
Sumber Daya Bermanfaat
• Pengenalan Komprehensif BGA
• Alasan Teratas Retak pada Solder BGA
• Masalah Bola Solder pada Komponen BGA dan Cara Menghindarinya
• Layanan Perakitan PCB Turnkey Lanjutan dari PCBCart
• Cara Mendapatkan Harga Perakitan PCB
• Cara Mengevaluasi Produsen PCB atau Perakit PCB