Tips Tata Letak yang Tidak Dapat Dilewatkan untuk Chip BGA
Dengan perkembangan teknologi pengemasan chip, BGA (ball grid array) telah dianggap sebagai bentuk pengemasan standar. Sejauh menyangkut chip dengan ratusan pin, penerapan paket BGA menghadirkan keuntungan luar biasa.
Chip BGA menang atas chip QFP (quad flat package) dalam hal bentuk paket BGA. Paket BGA membuat ukuran fisik chip berkurang secara dramatis dengan susunan bola solder menggantikan kabel periferal pada chip QFP, yang sangat jelas ketika beberapa pin I/O tersedia. Luas permukaan BGA meningkat secara linier dengan peningkatan jumlah pin I/O sedangkan QFP meningkat dengan peningkatan kuadrat jumlah pin I/O. Akibatnya, paket BGA memberikan lebih banyak kemampuan manufaktur untuk komponen dengan banyak pin daripada QFP. Secara umum, jumlah pin I/O berkisar antara 250 hingga 1089, yang secara khusus ditentukan oleh jenis dan ukuran kemasan. Sejauh menyangkut manufakturabilitas, chip BGA juga berkinerja lebih baik daripada chip QFP. Pin chip paket BGA berbentuk bola dan didistribusikan dalam susunan 2D. Selain itu, pin I/O memiliki pitch yang lebih besar daripada QFP dan berfungsi sebagai bola keras yang tidak akan berubah bentuk karena kontak. Ketika datang ke produsen chip, kelebihan lain dari chip BGA terletak pada hasil yang tinggi. Tingkat cacat perakitan chip BGA biasanya pada 0,3ppm hingga 5ppm per pin yang dapat dianggap sama dengan tanpa cacat.
Berkat alasan yang dibahas di atas, chip paket BGA banyak diterapkan oleh perakit elektronik. Namun, bentuk paket BGA yang aneh menyebabkan risiko korsleting yang lebih tinggi dalam penyolderan kecuali beberapa tip tata letak penting dimanfaatkan dalam fase desain. Dengan demikian, artikel ini di bagian selanjutnya akan menunjukkan beberapa aturan tata letak penting untuk chip BGA sehingga efek penyolderan yang optimal dapat diperoleh dalam perakitan SMT (teknologi pemasangan permukaan).
• Pitch dan Spasi
Lapangan bola solder untuk paket BGA umumnya tetap di 50mil. Untuk memenuhi persyaratan teknologi yang digunakan dalam proses pembuatan PCB (papan sirkuit tercetak), jarak antara lubang tembus dan tepi pad harus minimal 8mil dan jarak antara jejak dan tepi pad dapat dikurangi menjadi 5mil hingga 6mil. Oleh karena itu, masuk akal untuk menentukan ukuran pad chip BGA antara 18mil hingga 25mil dan lebar tracing antara bola solder BGA harus berkisar antara 6mil hingga 8mil.
• Pengaturan Tanda Pemosisian
Karena paket BGA hampir tidak diperiksa dengan mata telanjang dan sambungan solder bahkan gagal dilihat dengan mata telanjang, tanda fidusia yang akurat harus disetel agar kompatibel dengan persyaratan inspeksi perakitan, perakitan manual, dan penggantian setelah pengerjaan ulang.
Ini adalah praktik yang biasa untuk menempatkan dua tanda fidusia di sudut berlawanan dari komponen BGA atau dua tanda sudut, seperti yang digambarkan pada gambar berikut.
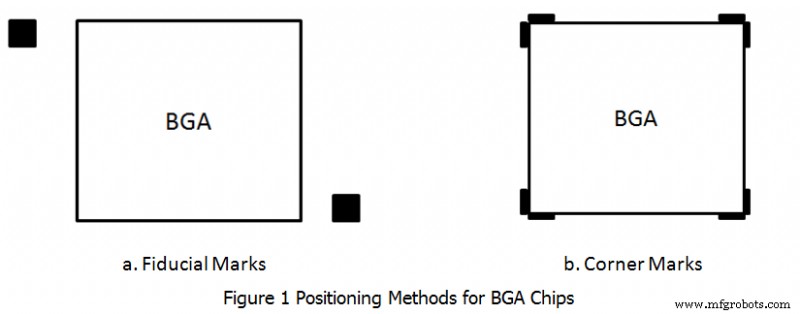
Baik tanda fidusia maupun tanda sudut ditempatkan pada lapisan ekuivalen dengan paket BGA, yaitu lapisan komponen. Tanda fidusia biasanya menampilkan tiga jenis bentuk:persegi, lingkaran dan segitiga yang ukurannya berkisar antara 20mil hingga 80mil dengan luas tanpa penutup solder tetap dengan ukuran 60mil. Lebar tanda sudut berkisar antara 8mil hingga 10mil, memberikan keselarasan paling akurat untuk grafis pad BGA.
• Konduktif Melalui Lubang di antara Bantalan
Secara umum, melalui lubang TIDAK boleh diatur antara bantalan dengan vias buta dan vias terkubur diganti. Namun demikian, metode itu akan menyebabkan biaya yang lebih tinggi untuk fabrikasi PCB. Jika melalui lubang harus diterapkan di antara bantalan, minyak masker solder harus digunakan untuk menghentikan solder agar tidak mengalir atau untuk mengisi atau menutup lubang untuk menghentikan korsleting dalam penyolderan.
• Pad
Di antara semua pin chip BGA, ada banyak yang berasal dari daya atau ground. Jika pad dirancang sebagai lubang tembus, banyak ruang akan disimpan untuk penelusuran. Namun, jenis desain ini hanya berfungsi untuk teknologi penyolderan reflow. Seperti metode perakitan lubang yang digunakan, volume lubang harus sesuai dengan jumlah pasta solder. Selama teknologi itu diterapkan, pasta solder akan melewati lubang yang terisi. Tanpa pertimbangan elemen tersebut, bola solder akan tenggelam ke dalam sambungan solder dengan konduktivitas yang turun.
Tata letak chip BGA tidak pernah dibatasi dalam aspek di atas dan hampir tidak mungkin satu artikel mencakup semua tip tata letak untuk chip BGA. Selain item di atas, tata letak komponen BGA juga terkait dengan kemampuan dan parameter peralatan dari produsen atau perakit kontrak. Misalnya, ukuran papan maksimum dan minimum yang dapat ditangani oleh pemasangan chip mungkin berbeda satu sama lain, sehingga memerlukan modifikasi desain yang sesuai agar kompatibel dengan persyaratan desain yang berbeda. Oleh karena itu, sangat penting untuk membuat konfirmasi lengkap tentang segala hal yang berkaitan dengan tata letak chip BGA untuk mendapatkan kinerja optimal dari PCB rakitan dan produk akhir lebih lanjut.
PCBCart Menawarkan Saran Tata Letak Komponen BGA yang Menyeluruh untuk Pencapaian Keseimbangan Optimal Anda antara Biaya dan Fungsi
Sebelum manufaktur atau perakitan nyata, waktu konfirmasi diperlukan oleh para insinyur dari PCBCart. Itu benar-benar berharga sebenarnya. Semua konfirmasi menghasilkan kecocokan sempurna antara desain Anda, kemampuan manufaktur kami, dan parameter peralatan kami, dan untuk sebagian besar penghematan waktu dan uang tanpa fungsi yang diharapkan terganggu. Ingin saran tata letak komponen BGA sekarang? Catatan:mereka GRATIS. Cobalah penawaran online dengan mengklik tombol di bawah ini. Kami akan menghitung biaya Perakitan PCB khusus Anda.
Sumber Daya Bermanfaat
• Pengenalan Teknologi Pengemasan BGA
• Faktor-Faktor yang Mempengaruhi Kualitas Perakitan BGA
• Penerapan Teknologi Surface Mount (SMT) pada Paket Ball Grid Array (BGA)
• Tindakan Efektif untuk Kontrol Kualitas pada Sambungan Solder Ball Grid Array (BGA)
• Persyaratan pada File Desain untuk Memastikan Perakitan BGA yang Efisien
• Cara Mendapatkan Penawaran Tepat untuk Permintaan Perakitan BGA Anda