Pada bagian ini, hubungan matematis antara parameter perangkat dan distribusi medan listrik di perangkat dibangun, yang diterapkan untuk menganalisis lapisan muatan dan efek tunneling. Secara bersamaan, model simulasi yang mencakup struktur simulasi, parameter material, dan model fisik dasar dibangun. Model analisis teoritis dan model simulasi didasarkan pada struktur vertikal SAGCM InGaAs/InAlAs APD.
Parameter perangkat, seperti tingkat doping, ketebalan, bahan, dan struktur, digunakan untuk membangun model matematika untuk menghitung distribusi medan listrik di APD. Teori fisika dasar yang mencakup persamaan Poisson, model lapisan penipisan, dan model sambungan PN dari perangkat semikonduktor dapat ditemukan pada bab 1, 2, dan 4 pada [23] dan [24]. Persamaan faktor perkalian persimpangan dapat ditemukan di [25], dan parameter material semikonduktor berasal dari [26]. Model yang disajikan mengadopsi persamaan Poisson, persamaan kerapatan arus tunneling, model depletion-layer, model teori junction, dan model lokal dari avalanche gain. Sistem koordinat matematis APD yang disederhanakan yang mencakup parameter struktur dasar (bahan, ketebalan, doping, dan konstanta dielektrik) disajikan pada Gambar. 1. Ini adalah struktur APD SACM yang disederhanakan yang mengabaikan lapisan perataan. Bahan lapisan kontak, lapisan muatan, dan lapisan perkalian adalah InAlAs, dan lapisan penyerapannya adalah InGaAs. Persimpangan lapisan dipisahkan oleh X n , 0, X m , X c , dan X a dan X p oleh x koordinat. Tingkat doping dinyatakan dengan N 0 , T 1 , T 2 , T 3 , dan T 4 , ketebalan lapisan dinyatakan dengan w 0 , dengan 1 , dengan 2 , dengan 3 , dan dengan 4 , dan konstanta dielektrik dinyatakan dengan ε s0 , ε s1 , ε s2 , ε s3 , dan ε s4 kontak A, perkalian, muatan, penyerapan, dan kontak B, masing-masing.
Sistem koordinat matematis yang disederhanakan dari SACM InGaAs/InAlAs APD. Menyajikan struktur APD yang disederhanakan yang digunakan untuk membangun model teoretis. Sistem koordinat matematika yang disederhanakan dari APD yang mencakup parameter struktur dasar (bahan, ketebalan, doping, dan konstanta dielektrik)
Persamaan 1 adalah persamaan Poisson, yang dapat menyelesaikan distribusi potensial listrik menggunakan rapat muatan ρ . Dalam persamaan ini, ρ sama dengan ion dopan N dalam model lapisan penipisan, w sama dengan ketebalan lapisan penipisan, dan ε adalah konstanta dielektrik bahan. Dalam model distribusi medan listrik sambungan PN umum, ρ adalah variabel yang bergantung pada ketebalan lapisan penipisan w dan ion dopan N . Dalam model ini, berubah setelah mempertimbangkan efek tunneling. Namun, sebelum mempertimbangkan efek terowongan, pertama-tama kami membangun distribusi medan listrik menggunakan metode umum.
$$ \frac{d\xi}{d x}=\frac{\rho }{\varepsilon }=\frac{q\times N}{\varepsilon } $$ (1)
Dengan memecahkan persamaan Poisson dengan parameter perangkat, ekspresi matematis medan listrik maksimum diperoleh. Ekspresi ini ditentukan oleh variasi ketebalan penetrasi di lapisan deplesi yang ditunjukkan pada Rumus 2 dan 3. Dalam ekspresi ini, parameter yang mencakup tingkat doping (N ), ketebalan lapisan penipisan (w ), dan konstanta dielektrik (ε) lapisan yang berbeda dapat ditemukan pada Gambar. 1.
$$ {\xi}_{\max (w)}={\sum}_{k=1}^4\left(-\frac{q\times {N}_k\times {w}_k}{\ varepsilon_{sk}}\right) $$ (2) $$ {\xi}_{\max (w)}=\frac{q\times {N}_0\times {w}_0}{\varepsilon_{s0 }} $$ (3)
Kemudian, distribusi medan listrik dapat diturunkan di semua titik menggunakan Rumus 4 dan 5. Kondisi batas mengabaikan potensial bawaan V br di Formula 6; oleh karena itu, hubungan matematis antara ketebalan lapisan penipisan dan tegangan bias dapat dihitung.
$$ {\xi}_{\left(x,w\right)}={\xi}_{\max (w)}+{\sum}_{k=1}^4\left(\frac{ q\times {N}_k\times \left|x\right|}{\varepsilon_{sk}}\right)\left({X}_p
Akhirnya, hubungan matematis antara distribusi medan listrik dan tegangan bias pada perangkat diperoleh dengan menggunakan Rumus 7–11: $$ \xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_{\mathrm{bias}}\kanan)} +\frac{q\times {N}_1\times \left|x\right|}{\varepsilon_{s1}}\left(0\ge x\ge {X}_m\right) $$ (7) $ $ \xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+ \frac{q\times {N}_1\times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times \left|x-{X}_m\right|} {\varepsilon_{s2}}\left({X}_m\ge x\ge {X}_c\right) $$ (8) $$ \xi \left(x,{V}_{\mathrm{bias} }\right)={\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times {N}_1\times {w}_1}{ \varepsilon_{s1}}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\times \left|x-{ X}_c\right|}{\varepsilon_{s3}}\left({X}_c\ge x\ge {X}_a\right) $$ (9) $$ \xi \left(x,{V} _{\mathrm{bias}}\right)={\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times {N}_1\ times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\ times {w}_3}{\varepsilon_{s3}}+\frac{q\times {N}_4\times \left|x-{X} _a\right|}{\varepsilon_{s4}}\left({X}_a\ge x\ge {X}_p\right) $$ (10) $$ \xi \left(x,{V}_{ \mathrm{bias}}\right)={\xi}_{\max \left({V}_{\mathrm{bias}}\right)}-\frac{q\times {N}_0\times x }{\varepsilon_{s0}}\left(0\le x\le {X}_n\kanan) $$ (11)
Dari model, setelah batas lapisan penipisan mencapai daerah kontak, Rumus 7-11 dapat digunakan untuk menganalisis medan listrik di setiap lapisan. Dalam APD praktis, lapisan penyerapan dan penggandaan secara tidak sengaja didoping dalam lapisan intrinsik. T 3 dan T 1 kurang dari N 2 . Dengan demikian, Formula 9 kira-kira sama dengan Formula 12. Inilah alasan mengapa lapisan muatan dapat mengontrol distribusi medan listrik di perangkat.
$$ {\displaystyle \begin{array}{l}\xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_ {\mathrm{bias}}\right)}+\frac{q\times {N}_1\times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times { w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\times \left|x-{X}_c\right|}{\varepsilon_{s3}}\\ {}\kern4em \approx {\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{ s2}}\left({X}_{\mathrm{c}}\ge x\ge {X}_a\right)\end{array}} $$ (12)
Dalam Formula 8, perbedaan medan listrik antara perkalian dan penyerapan ditentukan dengan menggunakan produk dari N 2 dan dengan 2 . T 2 adalah tingkat doping di lapisan muatan dan w 2 adalah ketebalan lapisan muatan. Untuk distribusi medan listrik yang sesuai di APD InGaAs/InAlAs, medan listrik di lapisan absorpsi (InGaAs) harus berada dalam nilai interval 50–180 kV/cm yang memastikan kecepatan yang cukup untuk pembawa yang diinduksi foto dan menghindari efek tunneling pada lapisan absorpsi [10]. Artinya, medan longsoran dalam perkalian harus berkurang menjadi 50–180 kV/cm dalam penyerapan oleh lapisan muatan. Dengan demikian, kita dapat menggunakan Formula 8 untuk menemukan perhitungan tingkat doping dan ketebalan lapisan muatan yang optimal. Saat lapisan perkalian adalah 200 nm (bidang longsoran E dalam perkaliannya adalah 6,7 × 10
5
V/cm sedangkan lapisan perkaliannya adalah 200 nm [27]); nilai yang dihitung dari tingkat doping dan ketebalan pada lapisan muatan dibandingkan dengan hasil dari [28,29,30,31,32,33] pada Gambar 2. Wilayah nilai teoretis sesuai dengan data eksperimen. Hasil ini membuktikan bahwa Formula 8 dapat digunakan untuk memprediksi tingkat doping dengan ketebalan yang berbeda pada lapisan muatan ketika ketebalan perkalian sudah pasti.
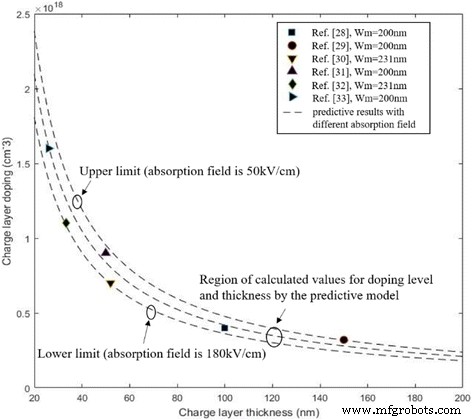
Perbandingan hasil teoretis dan data eksperimen dari berbagai laporan (w m = 200 nm). Simbol tertutup:tingkat doping dan ketebalan lapisan muatan dengan ketebalan perkalian 200 nm (kotak hitam, lingkaran hitam, segitiga hitam, segitiga siku-siku hitam) dan 231 nm (berlian hitam, segitiga hitam mengarah ke bawah) dalam referensi. Menyajikan nilai perhitungan lapisan muatan (tingkat doping dan ketebalan) dengan Formula 8 (bidang absorpsi adalah 50–180 kV/cm). Ketika medan absorpsi adalah 50 kV/cm, batas atas level doping pada lapisan muatan dapat diperoleh. Ketika medan absorpsi adalah 180 kV/cm, batas bawah level doping pada lapisan muatan dapat diperoleh. Kami membandingkan hasil teoritis dan data eksperimen dari berbagai laporan. Wilayah nilai teoretis sesuai dengan data eksperimen. Garis putus-putus nilai yang dihitung dari tingkat dan ketebalan doping dengan rumus
Kami menghitung tingkat doping optimal untuk ketebalan yang berbeda dari lapisan muatan dengan lapisan perkalian 300, 500, dan 700 nm, dan hasilnya disajikan pada Gambar 3. Hasil ini menggambarkan bahwa toleransi tingkat doping pada lapisan muatan adalah terkait dengan ketebalannya dan kisaran tingkat doping menurun dengan meningkatnya ketebalan lapisan muatan. Artinya, jika kita menerapkan wilayah muatan yang tebal, hanya kisaran kecil tingkat doping di lapisan muatan yang akan ada untuk memenuhi medan listrik yang optimal. Akibatnya, kinerja APD bervariasi secara signifikan melalui beberapa persen penyimpangan konsentrasi doping di lapisan muatan yang lebih tebal. Di bagian "Hasil dan Diskusi", struktur praktis APD disimulasikan untuk mempelajari dan memverifikasi analisis teoretis, yang mencakup pengaruh ketebalan lapisan muatan pada kisaran level doping di lapisan muatan dan variasi kinerja untuk ketebalan lapisan muatan yang berbeda di APD.

Tingkat doping dan ketebalan lapisan muatan yang optimal untuk lapisan penggandaan yang berbeda. Garis padat:w m = 300 nm. Garis putus-putus:w m = 500 nm. Garis titik:w m = 700 nm. Menyajikan nilai yang dihitung dari lapisan muatan (tingkat doping dan ketebalan) dengan rumus sementara bidang lapisan absorpsi cocok. Ketebalan lapisan perkalian adalah 300, 500, dan 700 nm. Ketika ketebalan lapisan perkalian sudah pasti, kita dapat menggunakan rumus untuk mencari tingkat doping dan ketebalan lapisan muatan yang optimal
Model Teoretis dengan Pertimbangan Tunneling
Model analisis di atas adalah tentang distribusi medan listrik di perangkat dan berdasarkan premis bahwa ρ adalah ion dopan pada lapisan deplesi. Jika ada medan listrik yang cukup tinggi di dalam lapisan absorpsi, pembengkokan pita lokal mungkin cukup untuk memungkinkan elektron mengalir [34]. Oleh karena itu, tunneling elektron dapat terjadi. Dari diagram skema tunneling pada Gambar. 4, ketika lapisan penyerapan memiliki tunneling breakdown, efek tunneling mengubah kerapatan muatan ρ , muatan positif dalam penyerapan meningkat, dan muatan negatif dalam perkalian dan lapisan muatan meningkat. Jadi, ρ tidak sama dengan densitas muatan ion dopan pada lapisan deplesi saat efek tunneling muncul. Rumus yang telah dibahas sebelumnya akan berubah setelah mempertimbangkan efek tunneling.

Proses tunneling dan perubahan densitas muatan pada lapisan perkalian dan penyerapan. Menyajikan diagram skema proses tunneling di perangkat. Jika ada medan listrik yang cukup tinggi di dalam lapisan absorpsi, pembengkokan pita lokal mungkin cukup untuk memungkinkan elektron mengalir. Ketika lapisan absorpsi mengalami breakdown tunneling, muatan positif dalam absorpsi meningkat dan muatan negatif pada lapisan perkalian dan muatan meningkat. Jadi, ρ tidak sama dengan densitas muatan ion dopan pada lapisan deplesi saat efek tunneling muncul
Tingkat generasi G bbt terowongan band-to-band dijelaskan dalam Formula 13 [35, 36].
$$ {G}_{bbt}={\left(\frac{2{m}^{\ast }}{E_g}\right)}^{1/2}\frac{q^2{E_p}^ {\gamma }}{{\left(2\pi \right)}^3{\hbar}^2}\exp \left(\frac{-\pi }{4{q\mathit{\hbar E}} _p}{\left(2{m}^{\ast}\times {E_g}^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex} {$2$}\right.}\right)=A\times {E_p}^{\gamma}\times \exp \left(-\frac{B}{E_p}\right) $$ (13)
Di Formula 13, E g adalah celah pita energi InGaAs, m* (sama dengan 0,04 m e ) adalah massa tereduksi efektif, E p adalah kerusakan medan listrik di lapisan penyerapan, dan γ adalah parameter yang dapat ditentukan pengguna yang biasanya dibatasi hingga 1~2. A dan B adalah parameter karakterisasi. Kami menghitung G bbt dengan γ . yang berbeda , dan hasilnya ditunjukkan pada Gambar. 5. Dapat ditemukan bahwa G bbt mengadaptasi urutan besarnya yang sama untuk tingkat doping lapisan muatan sementara γ dibatasi hingga 1~1.5.

G btt untuk berbagai bidang di lapisan penyerapan dengan γ . yang berbeda . Nilai γ adalah 1.0 (bintang hitam), 1.1 (segitiga hitam mengarah ke bawah), 1.2 (berlian hitam), 1.3 (segitiga hitam), 1.4 (kotak hitam), 1.5 (lingkaran hitam). Menyajikan hasil perhitungan G btt oleh Rumus 13. Ketika medan absorpsi melebihi 19 kV/cm, G bbt bertahap meningkat. Juga dapat ditemukan bahwa G bbt mengadaptasi urutan besarnya yang sama untuk tingkat doping lapisan muatan sementara γ dibatasi hingga 1~1,5
Akibatnya, kerapatan muatan ρ adalah variabel dan ditentukan oleh efek tunneling dan ion dopan di terowongan penyerapan. Pada kesempatan kali ini, Formula 1 akan diubah menjadi Formula 14 dan medan listrik pada lapisan perkalian akan dijelaskan oleh Formula 15. w terowongan adalah lapisan penipisan efektif dari proses tunneling [35]. Dengan demikian, perubahan bidang longsoran dapat dijelaskan dengan Formula 16, dan bidang longsoran akan berkurang dalam perkalian dengan efek tunneling.
$$ \frac{d\xi}{dx}=\frac{\rho }{\varepsilon }=\frac{q\times \left(N+{G}_{btt}\right)}{\varepsilon }, {E}_p>
1,8\times {10}^5V/ cm $$ (14) $$ \xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{ \max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times \left({N}_1\times \left|x\right|+{G}_{bbt }\times {w}_{\mathrm{tunnel}}\right)}{\varepsilon_{s1}}\left(0\ge x\ge {X}_m\right) $$ (15) $$ \delta \xi \left(x,{V}_{\mathrm{bias}}\right)=\delta E=\frac{q\times {G}_{btt}\times {w}_{\mathrm{terowongan }}}{\varepsilon_{\mathrm{s}3}} $$ (16)
Koefisien ionisasi elektron dan lubang dijelaskan oleh Rumus 17 dan 18 di [18]. E adalah bidang longsoran dalam perkalian.
$$ \alpha ={a}_n{e}^{\raisebox{1ex}{$-{b}_n$}\!\left/ \!\raisebox{-1ex}{$E$}\right.} $$ (17) $$ \beta ={a}_p{e}^{\raisebox{1ex}{$-{b}_p$}\!\left/ \!\raisebox{-1ex}{$E$ }\benar.} $$ (18)
Pengaruh longsoran pembawa dicatat oleh model ionisasi dampak. Mengingat densitas pembawa yang sangat rendah dari lapisan perkalian dibandingkan dengan lapisan muatan, masuk akal untuk mengasumsikan bahwa medan listrik seragam di seluruh lapisan perkalian. Oleh karena itu, faktor perkalian (M n ) dapat dinyatakan sebagai Persamaan berikut. 19. Di sini, dengan m adalah ketebalan lapisan perkalian dan k adalah rasio koefisien ionisasi tumbukan yang ditentukan oleh α/β . Sejak k bervariasi sangat lambat dengan medan listrik, k kira-kira konstan untuk sedikit variasi w m [37].
$$ {M}_n=\frac{k-1}{k\times {e}^{-\alpha \left(1-\raisebox{1ex}{$1$}\!\left/ \!\raisebox{ -1ex}{$k$}\kanan.\kanan){w}_m}-1} $$ (19)
Dengan asumsi konstan w m dan tegangan bias, diferensiasi M n sehubungan dengan koefisien ionisasi elektron ada di Rumus 20 dan 21.
$$ \delta {M}_n\left|{}_{w=const\&V=const}\right.={M_n}^2{e}^{-\alpha \left(1-\raisebox{1ex} {$1$}\!\left/ \!\raisebox{-1ex}{$k$}\right.\right){w}_m}\times {w}_m\delta \alpha $$ (20) $$ \delta \alpha =\frac{\delta \alpha}{\delta E}={\alpha}_n{b}_n{e}^{\frac{-{b}_n}{E}}\frac{1 }{E^2} $$ (21)
Dalam Rumus 20 dan 21, δα/δE adalah positif. Diasumsikan bahwa 20% dari total lapisan penyerapan penipisan adalah w terowongan dan lapisan serapan setebal 400 nm. Dengan memecahkan Formula 16, hubungan antara δE dan medan absorpsi dengan γ . yang berbeda disajikan pada Gambar. 6. Dapat ditemukan bahwa δE mengadaptasi urutan besarnya yang sama untuk medan longsoran dalam perkalian. Dengan demikian, efek terowongan memiliki pengaruh pada medan longsoran dan M n akan berkurang dengan efek tunneling. Dalam analisis, kami berasumsi bahwa muatan negatif tidak dikalikan dalam perkalian dan model akan lebih teliti setelah mempertimbangkannya. Untuk memverifikasi dan menganalisis pengaruh efek tunneling pada struktur praktis APD, kami mensimulasikan hubungan antara efek tunneling dan bidang longsoran multiplikasi secara rinci di bagian “Hasil dan Diskusi”.

δE untuk berbagai bidang di lapisan penyerapan dengan γ . yang berbeda . Nilai γ adalah 1.0 (bintang hitam), 1.1 (segitiga hitam mengarah ke bawah), 1.2 (berlian hitam), 1.3 (segitiga hitam), 1.4 (kotak hitam), 1.5 (lingkaran hitam). Menyajikan hasil perhitungan δE dengan Rumus 16. Ketika medan absorpsi melebihi 19 kV/cm, δE bertahap meningkat. Juga dapat ditemukan bahwa δE mengadaptasi urutan besarnya yang sama untuk medan longsoran dalam perkalian. Dengan demikian, efek tunneling berpengaruh pada medan longsoran dengan efek tunneling
Model Struktur dan Simulasi
Sebuah simulasi perangkat semikonduktor TCAD digunakan untuk simulasi dan analisis. Mesin simulasi ini mendefinisikan model fisik dalam simulasi, dan hasilnya memiliki arti fisik [20]. Model fisik dasar disajikan sebagai berikut. Model difusi-hanyut, termasuk persamaan Poisson dan kontinuitas pembawa, digunakan untuk mensimulasikan distribusi medan listrik dan arus difusi IDIFF . Model tunneling band-to-band digunakan untuk arus tunneling band-to-band IB2B , dan model tunneling berbantuan trap digunakan untuk arus tunneling berbantuan trap ITAT . Generasi-rekombinasi saat ini IGR dijelaskan oleh model rekombinasi Shockley–Read–Hall, dan arus rekombinasi Auger IAUGER dijelaskan oleh model rekombinasi Auger. Arus gelap dijelaskan dengan jelas oleh mekanisme tersebut [38]. Perkalian longsoran dijelaskan oleh model ionisasi dampak Selberherr. Model dasar lainnya, termasuk statistik pembawa Fermi-Dirac, bergantung pada konsentrasi pembawa, mobilitas medan rendah, saturasi kecepatan, dan metode ray-tracing, digunakan untuk model simulasi, dan model simulasi yang ketat dibuat.
Struktur perangkat dalam simulasi mirip dengan struktur eksperimental di [13]. Penampang skema dari APD SAGCM InGaAs/InAlAs yang diterangi di atas ditunjukkan pada Gambar. 7. Struktur dari atas ke bawah secara berurutan dinamai sebagai lapisan kontak InGaAs, lapisan kelongsong InAlAs, lapisan penilaian InAlGaAs, lapisan penyerapan InGaAs, penilaian InAlGaAs lapisan, lapisan pengisian InAlAs, lapisan perkalian InAlAs, lapisan penutup InAlAs, lapisan kontak InP, dan substrat InP. Ketebalan dan doping setiap lapisan juga disajikan pada Gambar 7. Untuk menghindari pengaruh ketebalan pada hasil simulasi, kami memilih dua struktur simulasi. Satu struktur simulasi diberi nama APD-1 (lapisan perkalian dan absorpsi masing-masing berukuran 800 dan 1800 nm), dan struktur simulasi lainnya diberi nama APD-2 (lapisan perkalian dan absorpsi masing-masing berukuran 200 dan 600 nm).
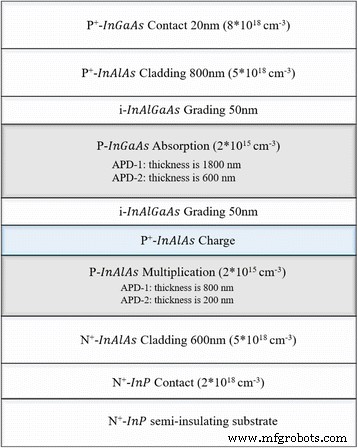
Struktur simulasi dan parameter APD. Menyajikan penampang skema dari SAGCM InGaAs/InAlAs APD-1 dan APD-2 dengan penerangan atas. Ini termasuk struktur, bahan, doping, dan ketebalan
Untuk menguji model simulasi, data eksperimen [13] dibandingkan dengan hasil simulasi. Dalam simulasi ini, kami menggunakan struktur yang sama dalam referensi, dan karakteristik tegangan arus perangkat diberikan. Gambar 8 menunjukkan hasil simulasi kami dan hasil eksperimen dalam referensi. Mereka memiliki tegangan tembus yang sama V pt dan tegangan tembus V br . Selain itu, hasil simulasi dan eksperimen sangat sesuai. Oleh karena itu, model dalam simulasi kami akurat. Parameter yang disebutkan di atas tercantum dalam Tabel 1.
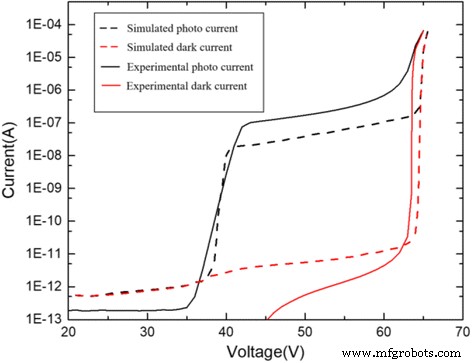
Hasil simulasi dibandingkan dengan hasil percobaan (arus foto dan arus gelap). Garis putus-putus hitam:arus foto simulasi. Garis putus-putus merah:simulasi arus gelap. Garis hitam pekat:arus foto eksperimental. Garis merah solid:arus gelap eksperimental. Menyajikan perbandingan hasil simulasi dan hasil percobaan. Model simulasi menggunakan parameter yang sama dari eksperimen dalam referensi
Hasil dan Diskusi
Pada bagian ini, analisis teoritis dan kesimpulan dipelajari dengan simulasi secara rinci. Pertama, pengaruh ketebalan lapisan muatan pada toleransi tingkat doping pada lapisan muatan dipelajari di bagian “Pengaruh Ketebalan Lapisan Muatan”. Kemudian, hubungan antara efek tunneling dan bidang longsoran multiplikasi dianalisis dan diverifikasi di bagian “Efek Tunneling pada Distribusi Medan Listrik”.
Pengaruh Ketebalan Lapisan Muatan
Dari [14], distribusi bidang yang sesuai di APD InGaAs/InAlAs harus mematuhi aturan tersebut. Jaminan V pt < V br dan V br V pt harus memiliki margin keamanan untuk memproses variasi dalam fluktuasi suhu dan rentang operasi. Pada lapisan absorpsi, medan listrik harus lebih besar dari 50–100 kV/cm untuk memastikan kecepatan yang cukup untuk pembawa yang diinduksi foto. Secara bersamaan, medan listrik harus kurang dari 180 kV/cm untuk menghindari efek tunneling pada lapisan absorpsi. Distribusi medan listrik sangat mempengaruhi kinerja perangkat. The choice of electric field in the absorption layer has a balancing of the tradeoff between small transit time, dark current, and high responsivity for the practical requirement.
In the simulation, we used the structure of APD-1 (multiplication is 800 nm thick) and adjusted the charge layer thickness from 50 to 210 nm to study the influence of charge layer thickness on doping level range and verify the theoretical conclusions in analytical model. In the simulation, we selected different doping level ranges in the charge layer so that the electric field distribution complies with the rules. The simulation results on the relationship between thickness and doping level range in the charge layer are presented in Fig. 9a. As the charge layer thickness increases, the suitable doping level range in charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. The simulation result of APD-2 (with a thickness of multiplication of 200 nm) is presented in Fig. 9b, which has a similar result. Moreover, it can be found that the calculated results of Fig. 2 and simulation results of Fig. 9b match well as shown in Fig. 9c. The small difference between the calculated results and simulation results is caused by the different values of avalanche field in the simulation and calculation. The avalanche field in simulation engine is used 6.4 × 10
5
V/cm, while in the calculation, we use the value of 6.7 × 10
5
V/cm from [27].

a Relationship between suitable doping level and thickness of charge layer (APD-1). The thickness of charge layer is 50 nm (black square), 90 nm (black circle), 130 nm (black triangle), 170 nm (black down-pointing triangle), 210 nm (black diamond). a presents the suitable doping level region for different thickness of charge layer. As the charge layer thickness increases, the suitable doping level range in the charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. b Relationship between suitable doping level and thickness of charge layer (APD-2). The thickness of charge layer is 50 nm (black square), 70 nm (black circle), 90 nm (black triangle), 110 nm (black down-pointing triangle), 130 nm (black diamond), and 150 nm (black pentagon). The figure description of b is similar to a . c Comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. Dashed line:calculated results. Closed symbols:simulated results (black square). c presents the comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. The calculated results and simulated results correspond well
The charge layer thicknesses of 210 and 50 nm (APD-1) were selected to show the simulation details and the influence of doping level on the electric field distribution. Figure 10a, c shows the current simulation results of different doping levels in thicknesses of 210 and 50 nm, respectively. Figure 10b, d shows the electric field distribution simulation results using the same structure. The simulation results show that thicknesses of 210 and 50 nm have doping level ranges of 1.0 × 10
17
–1.3 × 10
17
cm
−3
and 3.9 × 10
17
–5.7 × 10
17
cm
−3
, masing-masing.

a Photocurrent and dark current with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in the charge layer is 1.3 × 10
17
cm
−3
. Dashed line:doping level in charge layer is 1.15 × 10
17
cm
−3
. Dashed dot line:doping level in charge layer is 1.0 × 10
17
cm
−3
. a Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the punch-through voltage, breakdown voltage, and current-voltage characteristic. b Avalanche field with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in charge layer is 1.3 × 10
17
cm
−3
. Dashed line:doping level in charge layer is 1.15 × 10
17
cm
−3
. Dashed dot line:doping level in charge layer is 1.0 × 10
17
cm
−3
. b Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influenced the electric field distribution. c Photocurrent and dark current with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10
17
cm
−3
. Dashed line:doping level in charge layer is 4.8 × 10
17
cm
−3
. Dashed dot line:doping level in charge layer is 3.9 × 10
17
cm
−3
. c Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 50 nm has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the current-voltage characteristic. d Avalanche field with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10
17
cm
−3
. Dashed line:doping level in charge layer is 4.8 × 10
17
cm
−3
. Dashed dot line:doping level in charge layer is 3.9 × 10
17
cm
−3
. d Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 50 nm only has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the electric field distribution
Clearly, the device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the current-voltage characteristic and electric field distribution. As a result, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. This conclusion is the same as the theoretical analysis. Concurrently, when designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability.
Finally, the relationship between charge layer and multiplication thickness was simulated. Figure 11a presents the avalanche field with multiplication region thicknesses of 100, 200, and 300 nm in the APD-2 structure (with a charge layer thickness of 70 nm). Figure 11b presents the charge layer doping range with different multiplication thicknesses at the suitable electric field distribution condition. The charge layer thicknesses are 50, 70, and 90 nm. Clearly, a high avalanche field exists in the thin multiplication layer. As the multiplication region thickness decreases, the electric field difference between multiplication and absorption layers increases. As a result, a thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field.

a Avalanche breakdown electric field with different multiplication thicknesses. Solid line:w m = 100 nm. Dashed line:w m = 200 nm. Dashed dot line:w m = 300 nm. a Presents the simulation results of electric field distribution with different w m . As the w m decreases, the avalanche field in the multiplication increase. b Relationship between multiplication thickness and charge layer. The thickness of multiplication is 300 nm (black square), 200 nm (black circle), 100 nm (black triangle). b Presents the relationship between multiplication thickness and charge layer. A thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field
Tunneling Effect on the Electric Field Distribution
The simulation in this part will study the tunneling effect on the electric field in the device. From the theoretical analysis, the tunneling effect has an influence on the avalanche field in multiplication. Thus, the simulation will design to study the influence of electric field in the absorption layer that exceeds the tunneling threshold value. First, group A, with the structure of APD-1, charge layer thickness of 90 nm, and different charge layer doping levels of 1.4 × 10
17
–2.4 × 10
17
cm
−3
, was simulated for electric field distribution when the device avalanche breaks down. The result is shown in Fig. 12a. When the charge layer doping level exceeds 2.0 × 10
17
cm
−3
, the field in the absorption layer becomes lower than the tunneling threshold field and the avalanche field in the multiplication layer reaches the same value. However, when the doping level is less than 2.0 × 10
17
cm
−3
, the field in the absorption layer exceeds the tunneling threshold field and the avalanche field in the multiplication layer decreases with the decrease of the doping level in charge layer. Similar results were observed in the APD-2 structure (with a charge layer thickness of 90 nm and doping level of 2.2 × 10
17
–3.6*10
17
cm
−3
) (Fig. 12b). That is, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease.

a Avalanche breakdown electric field with different doping levels (APD-1). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. a Presents the simulation results of electric field distribution with different doping level while avalanche breakdown. When doping level of charge layer exceeds 2.0 × 10
17
cm
−3
, the field in the absorption layer becomes lower than the tunneling threshold field, and the avalanche field in the multiplication layer reaches the same value with different doping level. However, when the doping level is less than 2.0 × 10
17
cm
−3
, the field in the absorption layer exceeds the tunneling threshold field, and the avalanche field in the multiplication layer decreases with the decrease of the doping level. Thus, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease. Thus, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer when the device avalanche breaks down. b Avalanche breakdown electric field with different doping levels (APD-2). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. The figure description of b is similar to a . c Relationship between field and bias voltage in multiplication and absorption (APD-1). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). c Presents the relationship between the electric field and bias voltage in multiplication and absorption layers. When the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold. d Relationship between field and bias voltage in multiplication and absorption (APD-2). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). The figure legend of d is similar to a
Groups B (APD-1 thickness of 90 nm, doping level of 2.4 × 10
17
cm
−3
in charge layer and APD-2 thickness of 90 nm, doping level of 3.6 × 10
17
cm
−3
) were designed to demonstrate the relationship between the threshold electric field in the absorption layer and avalanche field in the multiplication layer. The multiplication and absorption electric fields vary with the bias voltage on the device. As shown in Fig. 12c, d, when the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, when the absorption field exceeds the tunneling threshold, the avalanche breakdown electric field in the multiplication layer plummets. Furthermore, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold.
The phenomenon in Fig. 12 can be explained by the theoretical analysis that tunneling has an influence on the charge density in the “Methods” section. When the electric field reaches the tunneling threshold value in the absorption layer, the charge density ρ becomes unequal to the dopant ion. The multiplication field will decrease as the negative ion increases, and the absorption field will increase as the positive ion increases. Concurrently, the absorption field slope will increase due to the tunneling effect. As a result, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer and the low dark current when the device avalanche breaks down.
Kesimpulan
In summary, we have presented a theoretical study and numerical simulation analysis involving the InGaAs/InAlAs APD. The mathematical relationship between the device parameters and electric field distribution in the device was built. And the tunneling effect was taken into consideration in the theoretical analysis. Through analysis and simulation, the influence of structure parameters on the device and the detailed relationship of each layer were fully understood in the device. Three important conclusions can be obtained from this paper. First, the doping level and thickness of the charge layer for different multiplication thicknesses can be calculated by the theoretical model in the “Methods” section. Calculated charge layer values (doping and thickness) are in agreement with the experiment results. Second, as the charge layer thickness increases, the suitable doping level range in charge layer decreases. Compared to the thinner charge layer, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. When designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability. Finally, the G btt of tunneling effect was calculated, and the influence of tunneling effect on the avalanche field was analyzed. We confirm that the avalanche field and multiplication factor (M n ) in the multiplication will decrease by the tunneling effect.
Singkatan
- 2D:
-
Two-dimensional
- APD:
-
Avalanche photodiode
- DCR:
-
Dark count rate
- SACM APDs:
-
Separate absorption, charge, and multiplication avalanche photodiodes
- SAGCMAPDs:
-
Separate absorption, grading, charge, and multiplication avalanche photodiodes
- SPAD:
-
Single-photon avalanche photodiode
- SPDE:
-
Single-photon detection efficiency
- SRH:
-
Shockley–Read–Hall